Threads
XF\Mvc\Entity\ArrayCollection Object
(
[entities:protected] => Array
(
[25212] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 57
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25212
[node_id] => 2
[title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[reply_count] => 0
[view_count] => 0
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780327628
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100406
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780327628
[last_post_id] => 100406
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25207] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 61
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25207
[node_id] => 2
[title] => Morgan Stanley reports Intel 18A yield at 50%
[reply_count] => 8
[view_count] => 708
[user_id] => 5185
[username] => Fred Chen
[post_date] => 1780242061
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100383
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780327435
[last_post_id] => 100405
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5185
[username] => Fred Chen
[username_date] => 0
[username_date_visible] => 0
[email] => chen.t.fred@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 4
[secondary_group_ids] =>
[display_style_group_id] => 4
[permission_combination_id] => 92
[message_count] => 2665
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1333032401
[last_activity] => 1780326001
[last_summary_email_date] => 1605940563
[trophy_points] => 113
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 1962
[warning_points] => 0
[is_staff] => 0
[secret_key] => 5m-bZq0HRSi9VA-96QONHJeevdQas5S8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25161] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 65
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25161
[node_id] => 2
[title] => Why Intel Still Trails TSMC In The High Stakes Foundry Race
[reply_count] => 19
[view_count] => 3181
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1779831414
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100263
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1780324806
[last_post_id] => 100404
[last_post_user_id] => 90182
[last_post_username] => siliconbruh999
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25107] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 69
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25107
[node_id] => 2
[title] => Exclusive: Inside MediaTek's Push to Lock Up T-Glass Supply — The Risks Behind Google's TPU Deal
[reply_count] => 2
[view_count] => 1080
[user_id] => 398583
[username] => karin623
[post_date] => 1778831217
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99925
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780309574
[last_post_id] => 100401
[last_post_user_id] => 12844
[last_post_username] => coldsolder215
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 66
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 398583
[username] => karin623
[username_date] => 0
[username_date_visible] => 0
[email] => karin623@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Hong_Kong
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 48
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1748753435
[last_activity] => 1780047423
[last_summary_email_date] => 1771856462
[trophy_points] => 18
[alerts_unviewed] => 4
[alerts_unread] => 4
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 69
[warning_points] => 0
[is_staff] => 0
[secret_key] => PBnrLVmUtkEL7YUKL8Ij_6L3tfKYRzDQ
[privacy_policy_accepted] => 1748753435
[terms_accepted] => 1748753435
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25211] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 73
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25211
[node_id] => 2
[title] => NVIDIA and TSMC Bring AI Into Fabs to Advance Semiconductor Design and Manufacturing
[reply_count] => 0
[view_count] => 283
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780294310
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100400
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780294310
[last_post_id] => 100400
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25202] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 77
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25202
[node_id] => 2
[title] => Semiconductor Price Increases
[reply_count] => 3
[view_count] => 782
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780157382
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100364
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780292136
[last_post_id] => 100399
[last_post_user_id] => 323224
[last_post_username] => cheesehead
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25210] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 81
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25210
[node_id] => 2
[title] => Nvidia GTC Taipei 2026 Keynote
[reply_count] => 0
[view_count] => 174
[user_id] => 14042
[username] => hist78
[post_date] => 1780285690
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100398
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780285690
[last_post_id] => 100398
[last_post_user_id] => 14042
[last_post_username] => hist78
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 78
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 14042
[username] => hist78
[username_date] => 0
[username_date_visible] => 0
[email] => ckckhcdc@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 0
[activity_visible] => 0
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 4378
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1389969050
[last_activity] => 1780325753
[last_summary_email_date] => 1605978520
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1604959511
[avatar_width] => 807
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 4237
[warning_points] => 0
[is_staff] => 0
[secret_key] => 2YRSnPrl4fVQSdv3R6uqHxqi6BDQOXve
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25209] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 85
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25209
[node_id] => 2
[title] => Scoop: First Windows PCs powered by Nvidia chips to debut next week
[reply_count] => 2
[view_count] => 445
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780246663
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100387
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780254031
[last_post_id] => 100390
[last_post_user_id] => 90385
[last_post_username] => NY_Sam2
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25204] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 89
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25204
[node_id] => 2
[title] => Why governance matters: listen to Mark Carney at the Economic Club in NYC on 28 May 2026
[reply_count] => 8
[view_count] => 397
[user_id] => 19450
[username] => user nl
[post_date] => 1780205922
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100372
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780253406
[last_post_id] => 100389
[last_post_user_id] => 19450
[last_post_username] => user nl
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 86
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 1
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 597
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1780326484
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 438
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25208] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 93
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25208
[node_id] => 2
[title] => DRAM/HBM supply-demand balance
[reply_count] => 0
[view_count] => 195
[user_id] => 323177
[username] => Ole Hoejlund
[post_date] => 1780245519
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100386
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780245519
[last_post_id] => 100386
[last_post_user_id] => 323177
[last_post_username] => Ole Hoejlund
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 90
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 323177
[username] => Ole Hoejlund
[username_date] => 0
[username_date_visible] => 0
[email] => ole_hoejlund@hotmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 8
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1675687290
[last_activity] => 1780293093
[last_summary_email_date] => 1757427604
[trophy_points] => 3
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 9
[warning_points] => 0
[is_staff] => 0
[secret_key] => wOU0pE-L-zbt1v35m2cDzblnYzsGeGlB
[privacy_policy_accepted] => 1675687290
[terms_accepted] => 1675687290
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25205] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 97
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25205
[node_id] => 2
[title] => Samsung SF2 transistor density benchmark against 18A and N3P
[reply_count] => 2
[view_count] => 399
[user_id] => 5185
[username] => Fred Chen
[post_date] => 1780230027
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100379
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780233699
[last_post_id] => 100382
[last_post_user_id] => 90182
[last_post_username] => siliconbruh999
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5185
[username] => Fred Chen
[username_date] => 0
[username_date_visible] => 0
[email] => chen.t.fred@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 4
[secondary_group_ids] =>
[display_style_group_id] => 4
[permission_combination_id] => 92
[message_count] => 2665
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1333032401
[last_activity] => 1780326001
[last_summary_email_date] => 1605940563
[trophy_points] => 113
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 1962
[warning_points] => 0
[is_staff] => 0
[secret_key] => 5m-bZq0HRSi9VA-96QONHJeevdQas5S8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25206] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 101
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25206
[node_id] => 2
[title] => Anastasia on xLight's FEL-EUV and China researchers on ns and ps laser-produced plasma EUV sources
[reply_count] => 0
[view_count] => 225
[user_id] => 19450
[username] => user nl
[post_date] => 1780232245
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100381
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780232245
[last_post_id] => 100381
[last_post_user_id] => 19450
[last_post_username] => user nl
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 86
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 1
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 597
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1780326484
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 438
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25203] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 105
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25203
[node_id] => 2
[title] => NVIDIA's Madison Huang Meets Students at Seoul National University
[reply_count] => 0
[view_count] => 360
[user_id] => 14042
[username] => hist78
[post_date] => 1780187740
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100369
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780187740
[last_post_id] => 100369
[last_post_user_id] => 14042
[last_post_username] => hist78
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 78
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 14042
[username] => hist78
[username_date] => 0
[username_date_visible] => 0
[email] => ckckhcdc@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 0
[activity_visible] => 0
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 4378
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1389969050
[last_activity] => 1780325753
[last_summary_email_date] => 1605978520
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1604959511
[avatar_width] => 807
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 4237
[warning_points] => 0
[is_staff] => 0
[secret_key] => 2YRSnPrl4fVQSdv3R6uqHxqi6BDQOXve
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25200] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 109
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25200
[node_id] => 2
[title] => Startup aims to pay you to "Host a Datacenter in your yard"
[reply_count] => 2
[view_count] => 660
[user_id] => 35301
[username] => Xebec
[post_date] => 1780152402
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100361
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780183661
[last_post_id] => 100368
[last_post_user_id] => 14042
[last_post_username] => hist78
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 106
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 35301
[username] => Xebec
[username_date] => 0
[username_date_visible] => 0
[email] => john.heritage@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1785
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1598710106
[last_activity] => 1780311499
[last_summary_email_date] => 1631629203
[trophy_points] => 113
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 1760746858
[avatar_width] => 480
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 2161
[warning_points] => 0
[is_staff] => 0
[secret_key] => Y7XyJgQMBi7ZiDtuAyqNGDrBQQsi8JB4
[privacy_policy_accepted] => 1598710106
[terms_accepted] => 1598710106
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25198] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 113
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25198
[node_id] => 2
[title] => A new era of PC. 25.0528, 121.5990
[reply_count] => 1
[view_count] => 929
[user_id] => 36640
[username] => soAsian
[post_date] => 1780105067
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100351
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780152235
[last_post_id] => 100360
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 110
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 36640
[username] => soAsian
[username_date] => 0
[username_date_visible] => 0
[email] => jackmtsai@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Chicago
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 431
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1608139716
[last_activity] => 1780317629
[last_summary_email_date] => 1719670845
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 392
[warning_points] => 0
[is_staff] => 0
[secret_key] => 2oKeCTFkGUpMro5tcmj7WaY9HksB13Kw
[privacy_policy_accepted] => 1608139716
[terms_accepted] => 1608139716
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25199] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 117
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25199
[node_id] => 2
[title] => The Truth Behind Huawei's 1.4nm LogicFolding Claim
[reply_count] => 2
[view_count] => 1260
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780125454
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100356
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780152190
[last_post_id] => 100359
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25193] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 121
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25193
[node_id] => 2
[title] => Can Intel Save America?
[reply_count] => 7
[view_count] => 1221
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780035460
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100330
[first_post_reaction_score] => 3
[first_post_reactions] => {"1":3,"4":1}
[last_post_date] => 1780118535
[last_post_id] => 100355
[last_post_user_id] => 326256
[last_post_username] => Artificer60
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25192] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 125
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25192
[node_id] => 2
[title] => Energy Use Forcing Rethink of AI Chip Design, TSMC Says
[reply_count] => 2
[view_count] => 797
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780008301
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100327
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780078651
[last_post_id] => 100344
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25156] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 129
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25156
[node_id] => 2
[title] => China's Huawei reveals chip design breakthrough amid US sanctions
[reply_count] => 11
[view_count] => 2118
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1779760679
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100217
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1780060375
[last_post_id] => 100337
[last_post_user_id] => 335651
[last_post_username] => DanX
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15637
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780326027
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 81
[alerts_unread] => 81
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9498
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25167] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 133
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25167
[node_id] => 2
[title] => Interesting - TSMC might raise bonuses more than 30%, source says
[reply_count] => 1
[view_count] => 566
[user_id] => 20231
[username] => Barnsley
[post_date] => 1779905055
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100287
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1780050518
[last_post_id] => 100334
[last_post_user_id] => 36448
[last_post_username] => Paul2
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 130
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 20231
[username] => Barnsley
[username_date] => 0
[username_date_visible] => 0
[email] => apickering72@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Irkutsk
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1496
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1429440429
[last_activity] => 1780325412
[last_summary_email_date] => 1653315673
[trophy_points] => 113
[alerts_unviewed] => 8
[alerts_unread] => 8
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 789
[warning_points] => 0
[is_staff] => 0
[secret_key] => iAnkz9GTDfivRmH1BOp6OTrgESJR57G8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8683
[message_count] => 63495
[last_post_id] => 100406
[last_post_date] => 1780327628
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[last_thread_id] => 25212
[last_thread_title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[populated:protected] => 1
)
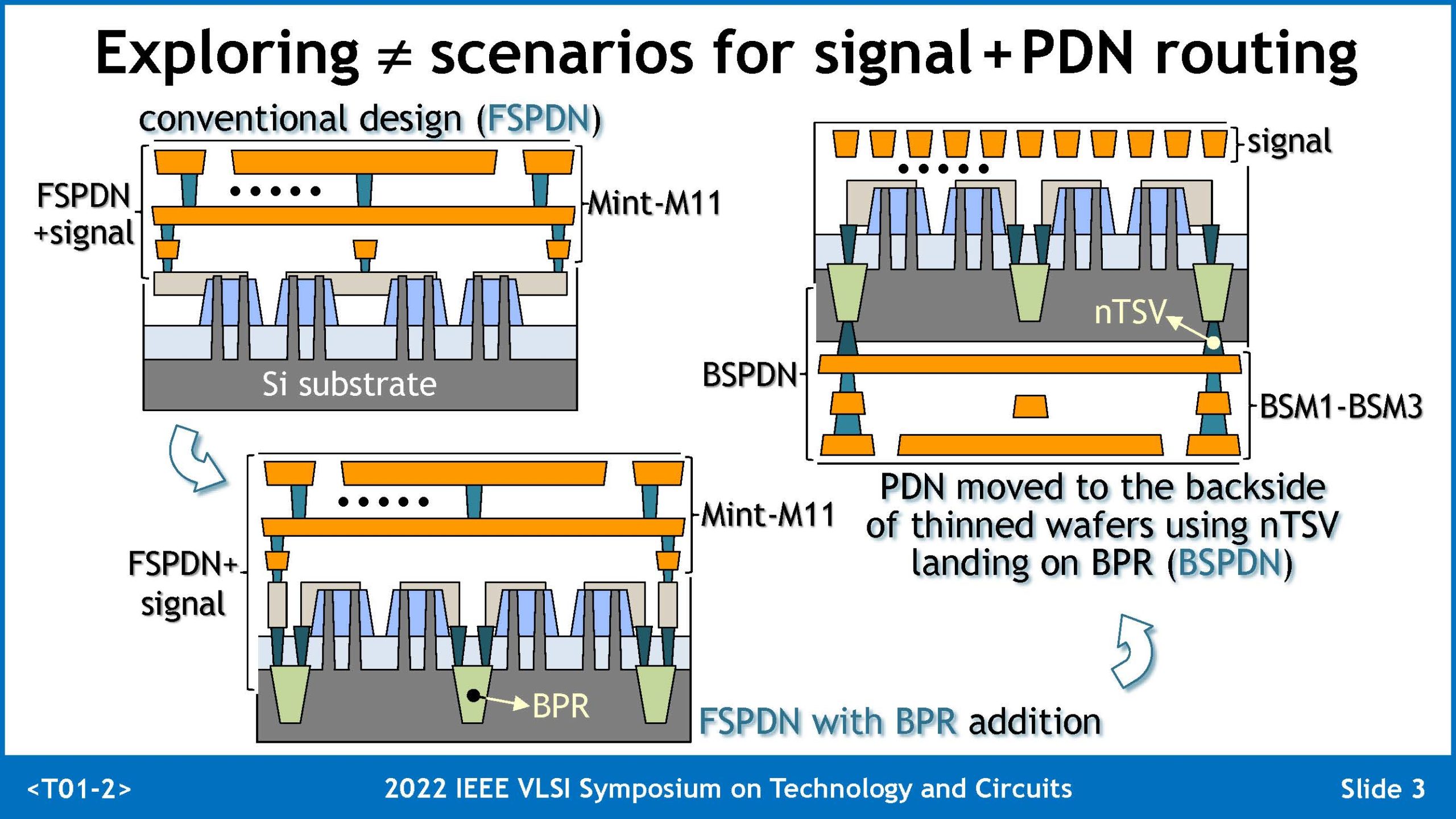
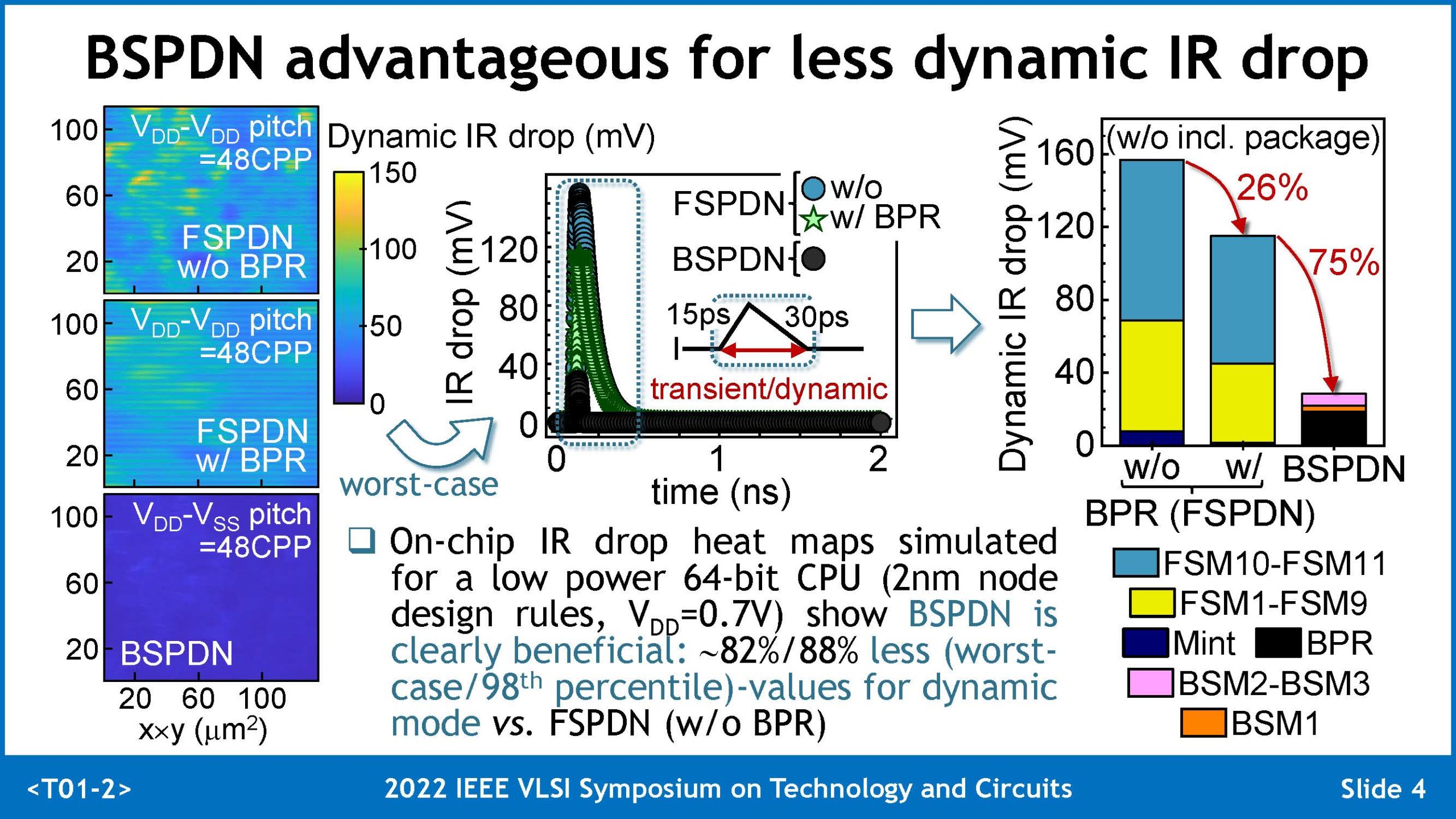
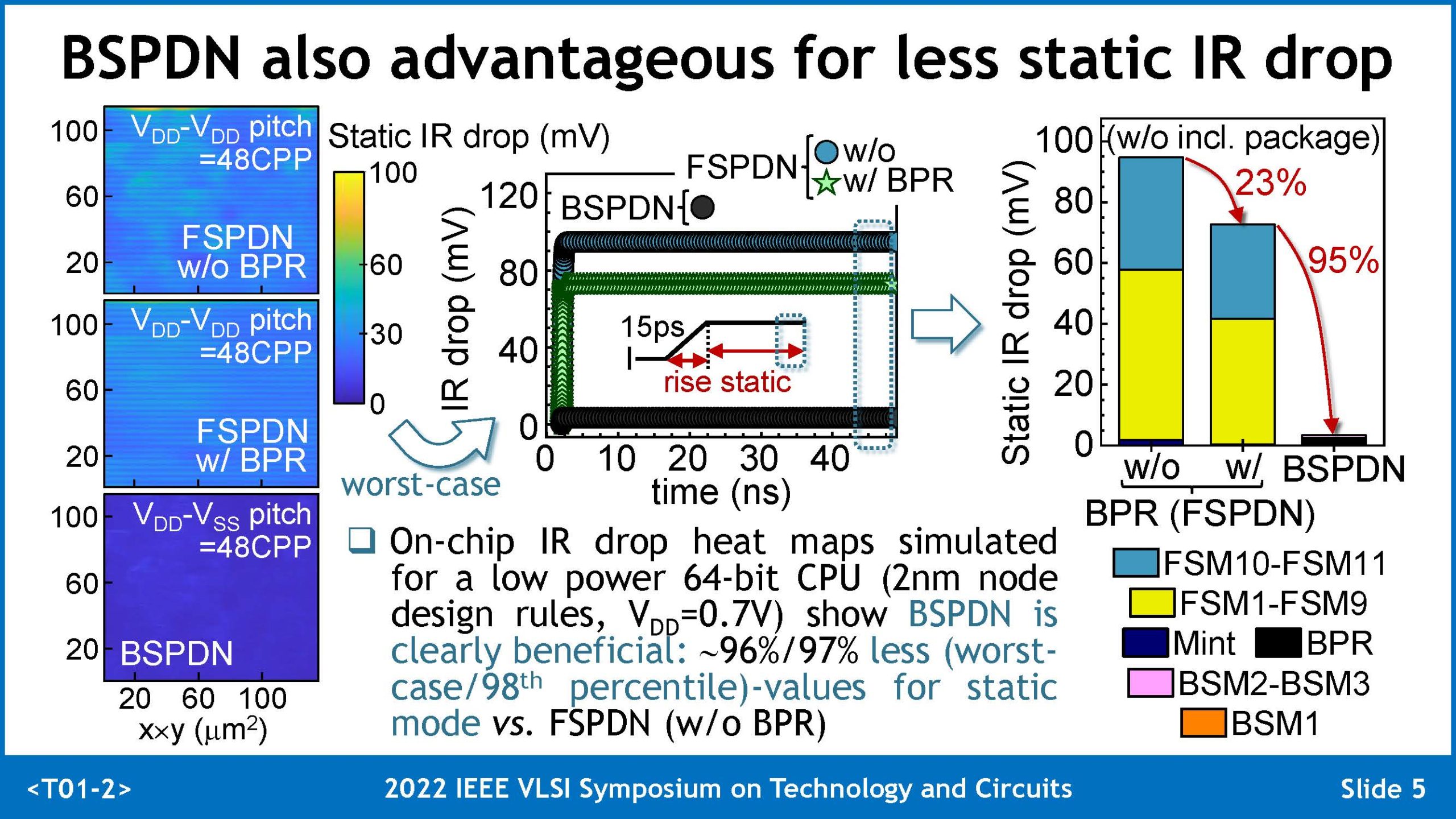
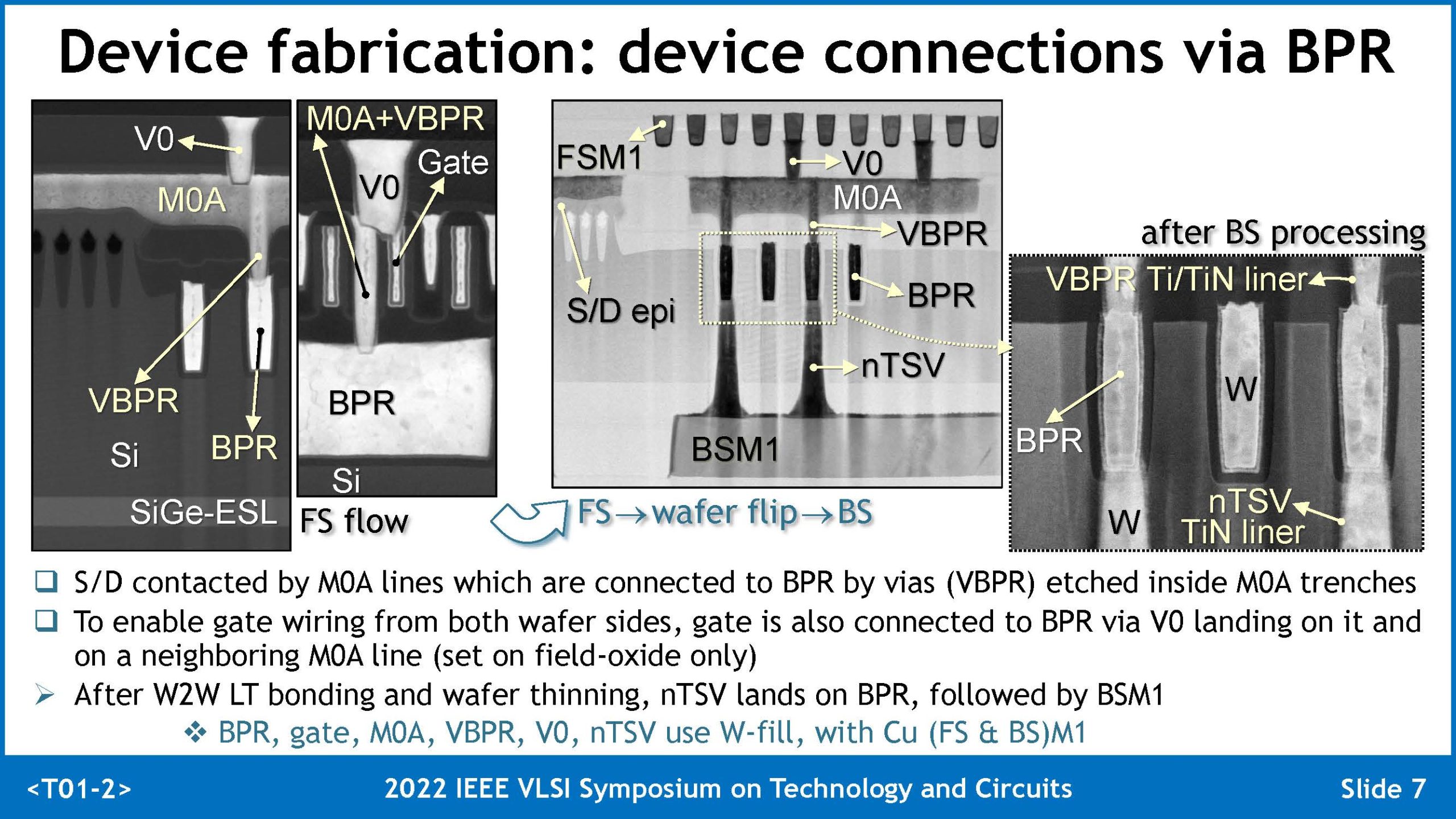


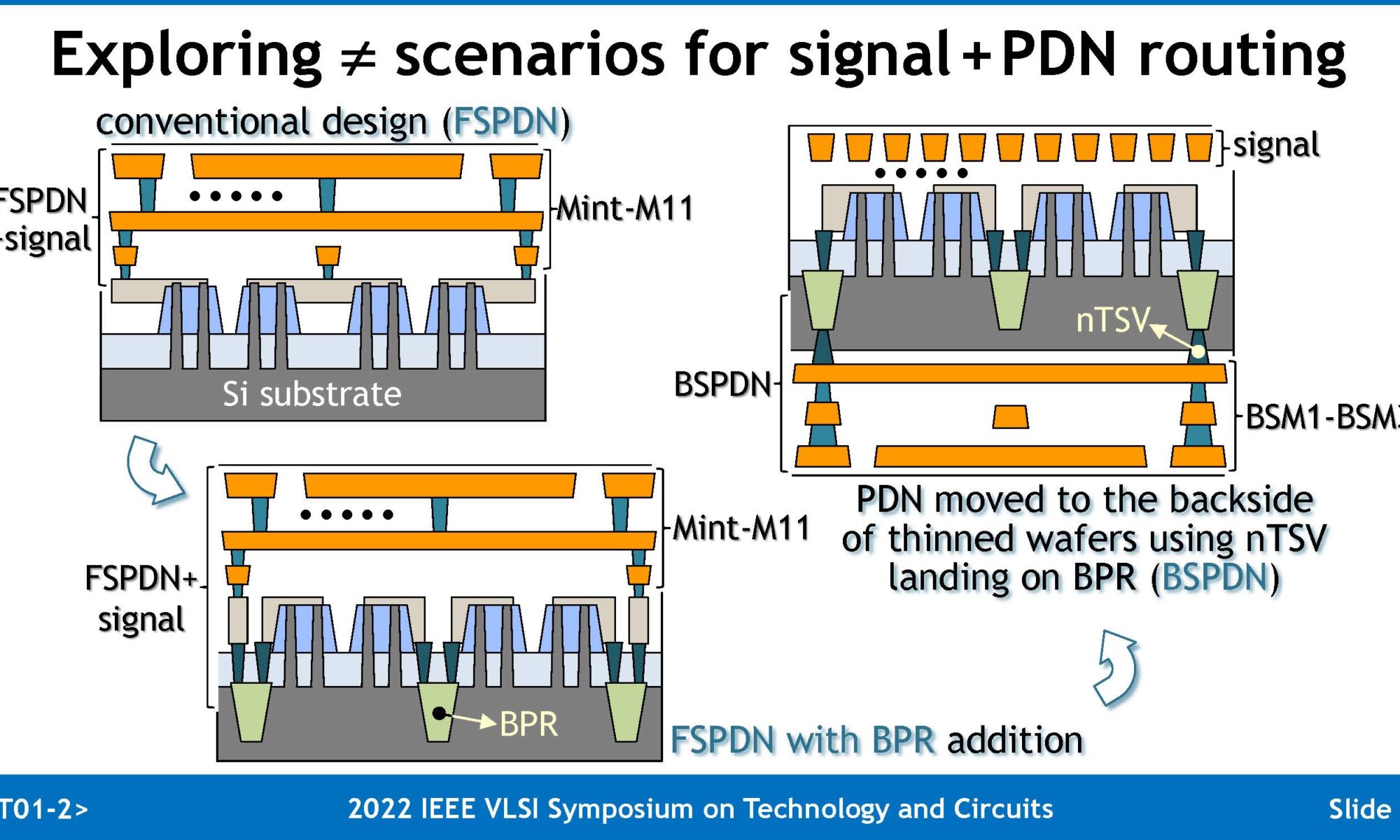





Comments
2 Replies to “Imec Buried Power Rail and Backside Power Delivery at VLSI”
You must register or log in to view/post comments.