Threads
XF\Mvc\Entity\ArrayCollection Object
(
[entities:protected] => Array
(
[25109] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 57
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25109
[node_id] => 2
[title] => World’s first native color LiDAR gives machines human-like vision
[reply_count] => 2
[view_count] => 319
[user_id] => 14042
[username] => hist78
[post_date] => 1778879963
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99936
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778989241
[last_post_id] => 99966
[last_post_user_id] => 14042
[last_post_username] => hist78
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 14042
[username] => hist78
[username_date] => 0
[username_date_visible] => 0
[email] => ckckhcdc@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 0
[activity_visible] => 0
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 4332
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1389969050
[last_activity] => 1778958496
[last_summary_email_date] => 1605978520
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 1
[avatar_date] => 1604959511
[avatar_width] => 807
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 4202
[warning_points] => 0
[is_staff] => 0
[secret_key] => 2YRSnPrl4fVQSdv3R6uqHxqi6BDQOXve
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25076] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 61
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25076
[node_id] => 2
[title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[reply_count] => 17
[view_count] => 1680
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778548540
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99798
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778974685
[last_post_id] => 99965
[last_post_user_id] => 326256
[last_post_username] => Artificer60
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25017] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 65
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25017
[node_id] => 2
[title] => Industry faces “acute” CPU shortage with hope that Intel 18A yields improve
[reply_count] => 48
[view_count] => 8440
[user_id] => 5185
[username] => Fred Chen
[post_date] => 1777451029
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99529
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1778965503
[last_post_id] => 99964
[last_post_user_id] => 334389
[last_post_username] => OneEng
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 62
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5185
[username] => Fred Chen
[username_date] => 0
[username_date_visible] => 0
[email] => chen.t.fred@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 4
[secondary_group_ids] =>
[display_style_group_id] => 4
[permission_combination_id] => 92
[message_count] => 2641
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1333032401
[last_activity] => 1778944993
[last_summary_email_date] => 1605940563
[trophy_points] => 113
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 1939
[warning_points] => 0
[is_staff] => 0
[secret_key] => 5m-bZq0HRSi9VA-96QONHJeevdQas5S8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25106] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 69
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25106
[node_id] => 2
[title] => Ming-Chi Kuo on Apple-Intel partnership, with TSMC lurking in the back
[reply_count] => 17
[view_count] => 1364
[user_id] => 90385
[username] => NY_Sam2
[post_date] => 1778794142
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99917
[first_post_reaction_score] => 3
[first_post_reactions] => {"1":3}
[last_post_date] => 1778960046
[last_post_id] => 99962
[last_post_user_id] => 334126
[last_post_username] => DepthFirst
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 66
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 90385
[username] => NY_Sam2
[username_date] => 0
[username_date_visible] => 0
[email] => petekennedy1989@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 50
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1642621712
[last_activity] => 1778794142
[last_summary_email_date] => 1767709207
[trophy_points] => 18
[alerts_unviewed] => 19
[alerts_unread] => 19
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 75
[warning_points] => 0
[is_staff] => 0
[secret_key] => egi-LmWHpsbQRZ7Y0Lk56hMyhUsrDhDE
[privacy_policy_accepted] => 1642621712
[terms_accepted] => 1642621712
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25074] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 73
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25074
[node_id] => 2
[title] => Cerebras to raise IPO price range to $150-$160 as demand surges, sources say
[reply_count] => 30
[view_count] => 2456
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778511949
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99783
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1778956720
[last_post_id] => 99961
[last_post_user_id] => 38697
[last_post_username] => blueone
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25098] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 77
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25098
[node_id] => 2
[title] => Trump lands in China for Xi summit with Nvidia CEO in tow
[reply_count] => 7
[view_count] => 1065
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778684918
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99878
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778956247
[last_post_id] => 99960
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25108] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 81
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25108
[node_id] => 2
[title] => Chinese memory module makers ramp up production as CXMT DDR5 breakthrough hits market
[reply_count] => 1
[view_count] => 404
[user_id] => 5185
[username] => Fred Chen
[post_date] => 1778848947
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99927
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778850209
[last_post_id] => 99928
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 62
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5185
[username] => Fred Chen
[username_date] => 0
[username_date_visible] => 0
[email] => chen.t.fred@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 4
[secondary_group_ids] =>
[display_style_group_id] => 4
[permission_combination_id] => 92
[message_count] => 2641
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1333032401
[last_activity] => 1778944993
[last_summary_email_date] => 1605940563
[trophy_points] => 113
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 1939
[warning_points] => 0
[is_staff] => 0
[secret_key] => 5m-bZq0HRSi9VA-96QONHJeevdQas5S8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25107] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 85
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25107
[node_id] => 2
[title] => Exclusive: Inside MediaTek's Push to Lock Up T-Glass Supply — The Risks Behind Google's TPU Deal
[reply_count] => 0
[view_count] => 370
[user_id] => 398583
[username] => karin623
[post_date] => 1778831217
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99925
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778831217
[last_post_id] => 99925
[last_post_user_id] => 398583
[last_post_username] => karin623
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 82
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 398583
[username] => karin623
[username_date] => 0
[username_date_visible] => 0
[email] => karin623@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Hong_Kong
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 47
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1748753435
[last_activity] => 1778831217
[last_summary_email_date] => 1771856462
[trophy_points] => 18
[alerts_unviewed] => 4
[alerts_unread] => 4
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 66
[warning_points] => 0
[is_staff] => 0
[secret_key] => PBnrLVmUtkEL7YUKL8Ij_6L3tfKYRzDQ
[privacy_policy_accepted] => 1748753435
[terms_accepted] => 1748753435
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25101] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 89
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25101
[node_id] => 2
[title] => Is AI the "automobile" of this generation?
[reply_count] => 5
[view_count] => 470
[user_id] => 20231
[username] => Barnsley
[post_date] => 1778735519
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99897
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778810558
[last_post_id] => 99922
[last_post_user_id] => 20231
[last_post_username] => Barnsley
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 86
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 20231
[username] => Barnsley
[username_date] => 0
[username_date_visible] => 0
[email] => apickering72@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Irkutsk
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1473
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1429440429
[last_activity] => 1778925738
[last_summary_email_date] => 1653315673
[trophy_points] => 113
[alerts_unviewed] => 13
[alerts_unread] => 13
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 768
[warning_points] => 0
[is_staff] => 0
[secret_key] => iAnkz9GTDfivRmH1BOp6OTrgESJR57G8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25102] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 93
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25102
[node_id] => 2
[title] => TSMC wins major modem chip order from Apple
[reply_count] => 2
[view_count] => 763
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778740690
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99898
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778807849
[last_post_id] => 99920
[last_post_user_id] => 443721
[last_post_username] => rinoali
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25104] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 97
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25104
[node_id] => 2
[title] => UMC Announces Release of 14nm eHV FinFET Platform, Advancing Innovation in Next-Generation Smartphone Displays
[reply_count] => 8
[view_count] => 545
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778769169
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99904
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778782352
[last_post_id] => 99915
[last_post_user_id] => 138292
[last_post_username] => MKWVentures
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25100] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 101
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25100
[node_id] => 2
[title] => MRC supercomputer networking, annonced by OpenAI and others
[reply_count] => 2
[view_count] => 388
[user_id] => 90385
[username] => NY_Sam2
[post_date] => 1778715848
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99890
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778722142
[last_post_id] => 99893
[last_post_user_id] => 38697
[last_post_username] => blueone
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 66
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 90385
[username] => NY_Sam2
[username_date] => 0
[username_date_visible] => 0
[email] => petekennedy1989@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 50
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1642621712
[last_activity] => 1778794142
[last_summary_email_date] => 1767709207
[trophy_points] => 18
[alerts_unviewed] => 19
[alerts_unread] => 19
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 75
[warning_points] => 0
[is_staff] => 0
[secret_key] => egi-LmWHpsbQRZ7Y0Lk56hMyhUsrDhDE
[privacy_policy_accepted] => 1642621712
[terms_accepted] => 1642621712
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25094] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 105
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25094
[node_id] => 2
[title] => Nvidia CEO Says He Has Plans to Either Change or Eliminate Every Single Person's Job With AI
[reply_count] => 9
[view_count] => 951
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778611122
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99847
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778689758
[last_post_id] => 99884
[last_post_user_id] => 38697
[last_post_username] => blueone
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25099] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 109
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25099
[node_id] => 2
[title] => China criticizes US chip equipment bill in run-up to Beijing talks
[reply_count] => 0
[view_count] => 411
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778686669
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99882
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778686669
[last_post_id] => 99882
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25097] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 113
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25097
[node_id] => 2
[title] => Tech Altar: Intel is back. Thank the old CEO.
[reply_count] => 2
[view_count] => 804
[user_id] => 16950
[username] => benb
[post_date] => 1778665576
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99867
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778675869
[last_post_id] => 99872
[last_post_user_id] => 38697
[last_post_username] => blueone
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 110
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 16950
[username] => benb
[username_date] => 0
[username_date_visible] => 0
[email] => benjamin.bayer@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Denver
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1067
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1408581209
[last_activity] => 1778980552
[last_summary_email_date] => 1777818003
[trophy_points] => 113
[alerts_unviewed] => 6
[alerts_unread] => 6
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 716
[warning_points] => 0
[is_staff] => 0
[secret_key] => pcdvBC5BP5tkj0uVO3VFPzfjLoO6RVRR
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25075] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 117
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25075
[node_id] => 2
[title] => AI Anthropic settles for $1.5B for copyrighted works of book authors
[reply_count] => 6
[view_count] => 618
[user_id] => 35301
[username] => Xebec
[post_date] => 1778531970
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99793
[first_post_reaction_score] => 2
[first_post_reactions] => {"3":1,"1":1}
[last_post_date] => 1778673040
[last_post_id] => 99870
[last_post_user_id] => 20231
[last_post_username] => Barnsley
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 114
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 35301
[username] => Xebec
[username_date] => 0
[username_date_visible] => 0
[email] => john.heritage@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1740
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1598710106
[last_activity] => 1778976690
[last_summary_email_date] => 1631629203
[trophy_points] => 113
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 1760746858
[avatar_width] => 480
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 2125
[warning_points] => 0
[is_staff] => 0
[secret_key] => Y7XyJgQMBi7ZiDtuAyqNGDrBQQsi8JB4
[privacy_policy_accepted] => 1598710106
[terms_accepted] => 1598710106
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25096] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 121
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25096
[node_id] => 2
[title] => Elon Musk’s Terafab chip factory in Texas could cost up to $119 billion, filing shows
[reply_count] => 0
[view_count] => 365
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778663941
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99866
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778663941
[last_post_id] => 99866
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25025] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 125
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25025
[node_id] => 2
[title] => Intel Prepares HBM Killer: HB3DM Memory Stacks with Z-Angle Technology
[reply_count] => 13
[view_count] => 2994
[user_id] => 332041
[username] => XYang2023
[post_date] => 1777512302
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99556
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1778595949
[last_post_id] => 99834
[last_post_user_id] => 5185
[last_post_username] => Fred Chen
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 122
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 332041
[username] => XYang2023
[username_date] => 0
[username_date_visible] => 0
[email] => xiao.yang17@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Australia/Sydney
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1388
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1708819075
[last_activity] => 1778321803
[last_summary_email_date] => 1771165277
[trophy_points] => 113
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 867
[warning_points] => 0
[is_staff] => 0
[secret_key] => NBs1n4BMtljiqSmfC-EZI_MMUn9Rzevl
[privacy_policy_accepted] => 1708819075
[terms_accepted] => 1708819075
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25093] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 129
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25093
[node_id] => 2
[title] => TSMC Flags Four Key Challenges in Arizona Buildout Even as U.S. Fab Beats Expectations
[reply_count] => 1
[view_count] => 386
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778581432
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99830
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778583618
[last_post_id] => 99831
[last_post_user_id] => 16950
[last_post_username] => benb
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15567
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778952105
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 78
[alerts_unread] => 78
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9444
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[23542] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 133
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 23542
[node_id] => 2
[title] => VSMC - New FAB going up in Singapore [Video]
[reply_count] => 6
[view_count] => 2699
[user_id] => 20231
[username] => Barnsley
[post_date] => 1757050231
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 91549
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1778581387
[last_post_id] => 99829
[last_post_user_id] => 20231
[last_post_username] => Barnsley
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 86
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 20231
[username] => Barnsley
[username_date] => 0
[username_date_visible] => 0
[email] => apickering72@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Irkutsk
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1473
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1429440429
[last_activity] => 1778925738
[last_summary_email_date] => 1653315673
[trophy_points] => 113
[alerts_unviewed] => 13
[alerts_unread] => 13
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 768
[warning_points] => 0
[is_staff] => 0
[secret_key] => iAnkz9GTDfivRmH1BOp6OTrgESJR57G8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8624
[message_count] => 63095
[last_post_id] => 99966
[last_post_date] => 1778989241
[last_post_user_id] => 14042
[last_post_username] => hist78
[last_thread_id] => 25109
[last_thread_title] => World’s first native color LiDAR gives machines human-like vision
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[populated:protected] => 1
)

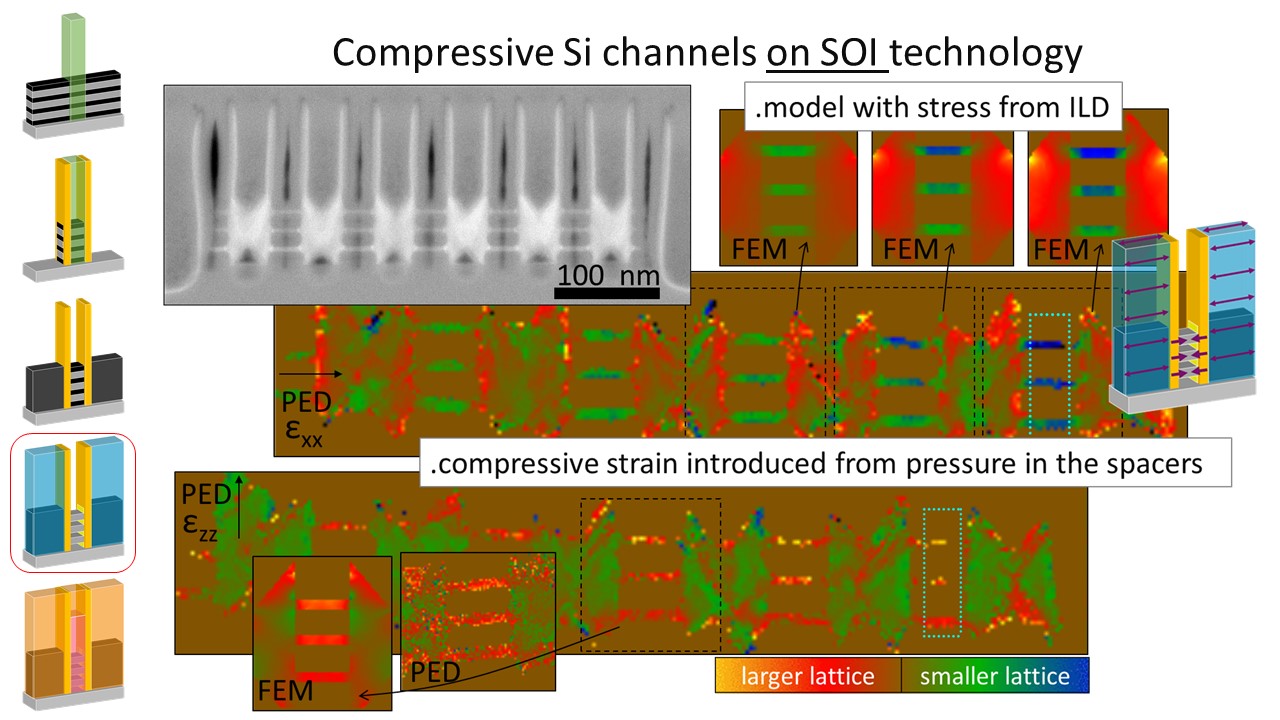






Comments
3 Replies to “IEDM 2019 – IBM and Leti”
You must register or log in to view/post comments.