Threads
XF\Mvc\Entity\ArrayCollection Object
(
[entities:protected] => Array
(
[25216] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 57
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25216
[node_id] => 2
[title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[reply_count] => 2
[view_count] => 158
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780412968
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100446
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780458086
[last_post_id] => 100464
[last_post_user_id] => 138698
[last_post_username] => bilau
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15643
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780459551
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 88
[alerts_unread] => 88
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9503
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25223] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 61
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25223
[node_id] => 2
[title] => LIVE: Intel CEO Lip-Bu Tan speaks at COMPUTEX
[reply_count] => 1
[view_count] => 120
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780447095
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100462
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780447323
[last_post_id] => 100463
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15643
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780459551
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 88
[alerts_unread] => 88
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9503
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25222] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 65
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25222
[node_id] => 2
[title] => Intel CEO says TSMC a ‘partner’ in chip production
[reply_count] => 0
[view_count] => 119
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780446836
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100461
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780446836
[last_post_id] => 100461
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15643
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780459551
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 88
[alerts_unread] => 88
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9503
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25212] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 69
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25212
[node_id] => 2
[title] => What are AI PCs that Nvidia's Jensen Huang is betting on?
[reply_count] => 20
[view_count] => 1244
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780327628
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100406
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780435014
[last_post_id] => 100460
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15643
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780459551
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 88
[alerts_unread] => 88
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9503
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25219] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 73
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25219
[node_id] => 2
[title] => Addressing the Advanced Glass Substrate Design Loop via Pipelined ML
[reply_count] => 0
[view_count] => 111
[user_id] => 445590
[username] => Mihir_Gupta
[post_date] => 1780429276
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100456
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780429276
[last_post_id] => 100456
[last_post_user_id] => 445590
[last_post_username] => Mihir_Gupta
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 70
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 445590
[username] => Mihir_Gupta
[username_date] => 0
[username_date_visible] => 0
[email] => mihir.gupta.tech@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Bangkok
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1779825168
[last_activity] => 1780435445
[last_summary_email_date] => 1779825168
[trophy_points] => 1
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 0
[warning_points] => 0
[is_staff] => 0
[secret_key] => 3JHJH9NH2auCHGA38W2kCX7igr73LUPT
[privacy_policy_accepted] => 1779825168
[terms_accepted] => 1779825168
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25215] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 77
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25215
[node_id] => 2
[title] => Bernie Sanders is proposing .. a 50% govt ownership of AI companies
[reply_count] => 9
[view_count] => 347
[user_id] => 35301
[username] => Xebec
[post_date] => 1780402890
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100436
[first_post_reaction_score] => 2
[first_post_reactions] => {"3":2}
[last_post_date] => 1780425826
[last_post_id] => 100454
[last_post_user_id] => 29779
[last_post_username] => tooLongInEDA
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 74
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 35301
[username] => Xebec
[username_date] => 0
[username_date_visible] => 0
[email] => john.heritage@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1792
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1598710106
[last_activity] => 1780443777
[last_summary_email_date] => 1631629203
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1760746858
[avatar_width] => 480
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 2170
[warning_points] => 0
[is_staff] => 0
[secret_key] => Y7XyJgQMBi7ZiDtuAyqNGDrBQQsi8JB4
[privacy_policy_accepted] => 1598710106
[terms_accepted] => 1598710106
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25218] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 81
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25218
[node_id] => 2
[title] => Intel Computex 2026 Keynote by CEO Li-Bu Tan
[reply_count] => 0
[view_count] => 231
[user_id] => 14042
[username] => hist78
[post_date] => 1780421162
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100453
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780421162
[last_post_id] => 100453
[last_post_user_id] => 14042
[last_post_username] => hist78
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 78
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 14042
[username] => hist78
[username_date] => 0
[username_date_visible] => 0
[email] => ckckhcdc@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 0
[activity_visible] => 0
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 4390
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1389969050
[last_activity] => 1780447114
[last_summary_email_date] => 1605978520
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1604959511
[avatar_width] => 807
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 4245
[warning_points] => 0
[is_staff] => 0
[secret_key] => 2YRSnPrl4fVQSdv3R6uqHxqi6BDQOXve
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25217] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 85
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25217
[node_id] => 2
[title] => COMPUTEX 2026 Arm CEO Keynote: The foundation for the agentic Al era
[reply_count] => 0
[view_count] => 152
[user_id] => 14042
[username] => hist78
[post_date] => 1780418654
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100450
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780418654
[last_post_id] => 100450
[last_post_user_id] => 14042
[last_post_username] => hist78
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 78
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 14042
[username] => hist78
[username_date] => 0
[username_date_visible] => 0
[email] => ckckhcdc@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 0
[activity_visible] => 0
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 4390
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1389969050
[last_activity] => 1780447114
[last_summary_email_date] => 1605978520
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1604959511
[avatar_width] => 807
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 4245
[warning_points] => 0
[is_staff] => 0
[secret_key] => 2YRSnPrl4fVQSdv3R6uqHxqi6BDQOXve
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25214] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 89
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25214
[node_id] => 2
[title] => If Taiwan Falls, the Fabs Burn: Why TSMC's Destruction Is the Inevitable Outcome of a China Invasion
[reply_count] => 1
[view_count] => 315
[user_id] => 5185
[username] => Fred Chen
[post_date] => 1780391441
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100433
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780403993
[last_post_id] => 100438
[last_post_user_id] => 36448
[last_post_username] => Paul2
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 86
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5185
[username] => Fred Chen
[username_date] => 0
[username_date_visible] => 0
[email] => chen.t.fred@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 4
[secondary_group_ids] =>
[display_style_group_id] => 4
[permission_combination_id] => 92
[message_count] => 2666
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1333032401
[last_activity] => 1780447453
[last_summary_email_date] => 1605940563
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 1963
[warning_points] => 0
[is_staff] => 0
[secret_key] => 5m-bZq0HRSi9VA-96QONHJeevdQas5S8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25213] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 93
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25213
[node_id] => 2
[title] => Pay workers ‘as much as possible’, says Nvidia CEO weighing in on AI profit-sharing debate
[reply_count] => 0
[view_count] => 218
[user_id] => 20231
[username] => Barnsley
[post_date] => 1780384464
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100432
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780384464
[last_post_id] => 100432
[last_post_user_id] => 20231
[last_post_username] => Barnsley
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 90
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 20231
[username] => Barnsley
[username_date] => 0
[username_date_visible] => 0
[email] => apickering72@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Irkutsk
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1502
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1429440429
[last_activity] => 1780458275
[last_summary_email_date] => 1653315673
[trophy_points] => 113
[alerts_unviewed] => 8
[alerts_unread] => 8
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 790
[warning_points] => 0
[is_staff] => 0
[secret_key] => iAnkz9GTDfivRmH1BOp6OTrgESJR57G8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25207] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 97
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25207
[node_id] => 2
[title] => Morgan Stanley reports Intel 18A yield at 50%
[reply_count] => 20
[view_count] => 1919
[user_id] => 5185
[username] => Fred Chen
[post_date] => 1780242061
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100383
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780345103
[last_post_id] => 100421
[last_post_user_id] => 14042
[last_post_username] => hist78
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 86
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5185
[username] => Fred Chen
[username_date] => 0
[username_date_visible] => 0
[email] => chen.t.fred@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 4
[secondary_group_ids] =>
[display_style_group_id] => 4
[permission_combination_id] => 92
[message_count] => 2666
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1333032401
[last_activity] => 1780447453
[last_summary_email_date] => 1605940563
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 1963
[warning_points] => 0
[is_staff] => 0
[secret_key] => 5m-bZq0HRSi9VA-96QONHJeevdQas5S8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25161] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 101
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25161
[node_id] => 2
[title] => Why Intel Still Trails TSMC In The High Stakes Foundry Race
[reply_count] => 20
[view_count] => 4160
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1779831414
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100263
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1780341574
[last_post_id] => 100413
[last_post_user_id] => 138292
[last_post_username] => MKWVentures
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15643
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780459551
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 88
[alerts_unread] => 88
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9503
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25107] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 105
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25107
[node_id] => 2
[title] => Exclusive: Inside MediaTek's Push to Lock Up T-Glass Supply — The Risks Behind Google's TPU Deal
[reply_count] => 2
[view_count] => 1282
[user_id] => 398583
[username] => karin623
[post_date] => 1778831217
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99925
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780309574
[last_post_id] => 100401
[last_post_user_id] => 12844
[last_post_username] => coldsolder215
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 102
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 398583
[username] => karin623
[username_date] => 0
[username_date_visible] => 0
[email] => karin623@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Hong_Kong
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 48
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1748753435
[last_activity] => 1780047423
[last_summary_email_date] => 1771856462
[trophy_points] => 18
[alerts_unviewed] => 4
[alerts_unread] => 4
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 69
[warning_points] => 0
[is_staff] => 0
[secret_key] => PBnrLVmUtkEL7YUKL8Ij_6L3tfKYRzDQ
[privacy_policy_accepted] => 1748753435
[terms_accepted] => 1748753435
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25211] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 109
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25211
[node_id] => 2
[title] => NVIDIA and TSMC Bring AI Into Fabs to Advance Semiconductor Design and Manufacturing
[reply_count] => 0
[view_count] => 593
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780294310
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100400
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780294310
[last_post_id] => 100400
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15643
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780459551
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 88
[alerts_unread] => 88
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9503
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25202] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 113
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25202
[node_id] => 2
[title] => Semiconductor Price Increases
[reply_count] => 3
[view_count] => 1160
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780157382
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100364
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780292136
[last_post_id] => 100399
[last_post_user_id] => 323224
[last_post_username] => cheesehead
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15643
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780459551
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 88
[alerts_unread] => 88
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9503
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25210] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 117
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25210
[node_id] => 2
[title] => Nvidia GTC Taipei 2026 Keynote
[reply_count] => 0
[view_count] => 355
[user_id] => 14042
[username] => hist78
[post_date] => 1780285690
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100398
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1780285690
[last_post_id] => 100398
[last_post_user_id] => 14042
[last_post_username] => hist78
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 78
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 14042
[username] => hist78
[username_date] => 0
[username_date_visible] => 0
[email] => ckckhcdc@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 0
[activity_visible] => 0
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 4390
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1389969050
[last_activity] => 1780447114
[last_summary_email_date] => 1605978520
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1604959511
[avatar_width] => 807
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 4245
[warning_points] => 0
[is_staff] => 0
[secret_key] => 2YRSnPrl4fVQSdv3R6uqHxqi6BDQOXve
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25209] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 121
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25209
[node_id] => 2
[title] => Scoop: First Windows PCs powered by Nvidia chips to debut next week
[reply_count] => 2
[view_count] => 794
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1780246663
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100387
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780254031
[last_post_id] => 100390
[last_post_user_id] => 90385
[last_post_username] => NY_Sam2
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15643
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1780459551
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 88
[alerts_unread] => 88
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9503
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25204] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 125
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25204
[node_id] => 2
[title] => Why governance matters: listen to Mark Carney at the Economic Club in NYC on 28 May 2026
[reply_count] => 8
[view_count] => 548
[user_id] => 19450
[username] => user nl
[post_date] => 1780205922
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100372
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780253406
[last_post_id] => 100389
[last_post_user_id] => 19450
[last_post_username] => user nl
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 122
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 1
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 597
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1780457995
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 438
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25208] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 129
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25208
[node_id] => 2
[title] => DRAM/HBM supply-demand balance
[reply_count] => 0
[view_count] => 362
[user_id] => 323177
[username] => Ole Hoejlund
[post_date] => 1780245519
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100386
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1780245519
[last_post_id] => 100386
[last_post_user_id] => 323177
[last_post_username] => Ole Hoejlund
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 126
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 323177
[username] => Ole Hoejlund
[username_date] => 0
[username_date_visible] => 0
[email] => ole_hoejlund@hotmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 8
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1675687290
[last_activity] => 1780433005
[last_summary_email_date] => 1757427604
[trophy_points] => 3
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 9
[warning_points] => 0
[is_staff] => 0
[secret_key] => wOU0pE-L-zbt1v35m2cDzblnYzsGeGlB
[privacy_policy_accepted] => 1675687290
[terms_accepted] => 1675687290
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25205] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 133
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25205
[node_id] => 2
[title] => Samsung SF2 transistor density benchmark against 18A and N3P
[reply_count] => 2
[view_count] => 568
[user_id] => 5185
[username] => Fred Chen
[post_date] => 1780230027
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 100379
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1780233699
[last_post_id] => 100382
[last_post_user_id] => 90182
[last_post_username] => siliconbruh999
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 86
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5185
[username] => Fred Chen
[username_date] => 0
[username_date_visible] => 0
[email] => chen.t.fred@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 4
[secondary_group_ids] =>
[display_style_group_id] => 4
[permission_combination_id] => 92
[message_count] => 2666
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1333032401
[last_activity] => 1780447453
[last_summary_email_date] => 1605940563
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 1963
[warning_points] => 0
[is_staff] => 0
[secret_key] => 5m-bZq0HRSi9VA-96QONHJeevdQas5S8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8692
[message_count] => 63550
[last_post_id] => 100464
[last_post_date] => 1780458086
[last_post_user_id] => 138698
[last_post_username] => bilau
[last_thread_id] => 25216
[last_thread_title] => Analysis: How a nudge from Nvidia propelled frugal Micron into the AI boom and a $1 trillion market cap
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[populated:protected] => 1
)
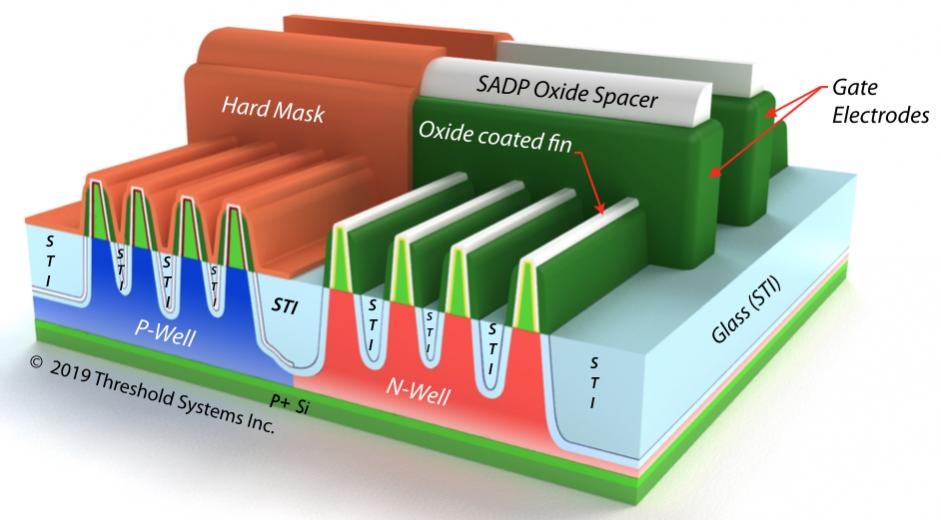
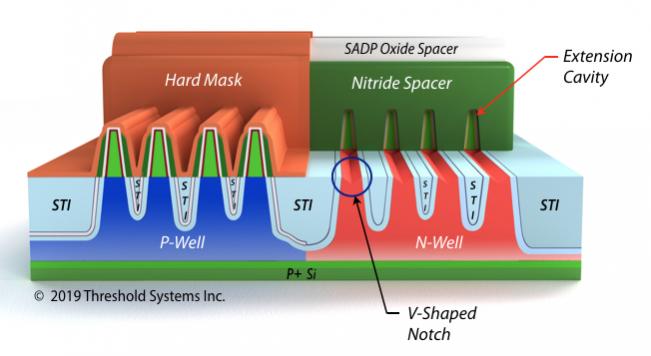
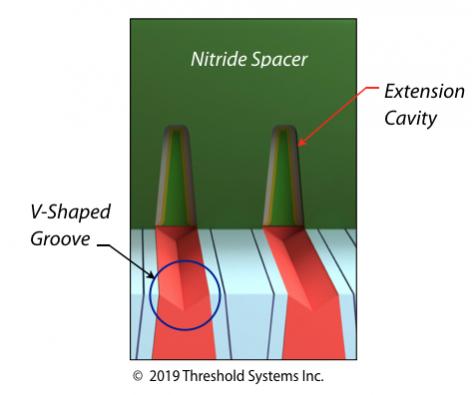
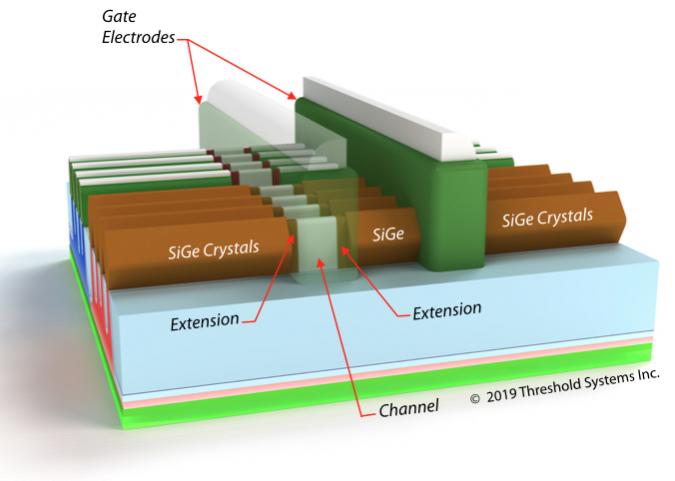
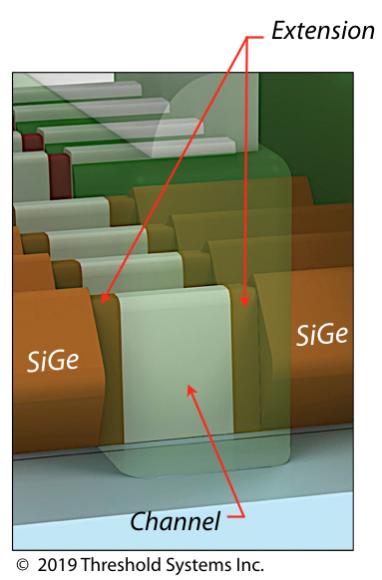
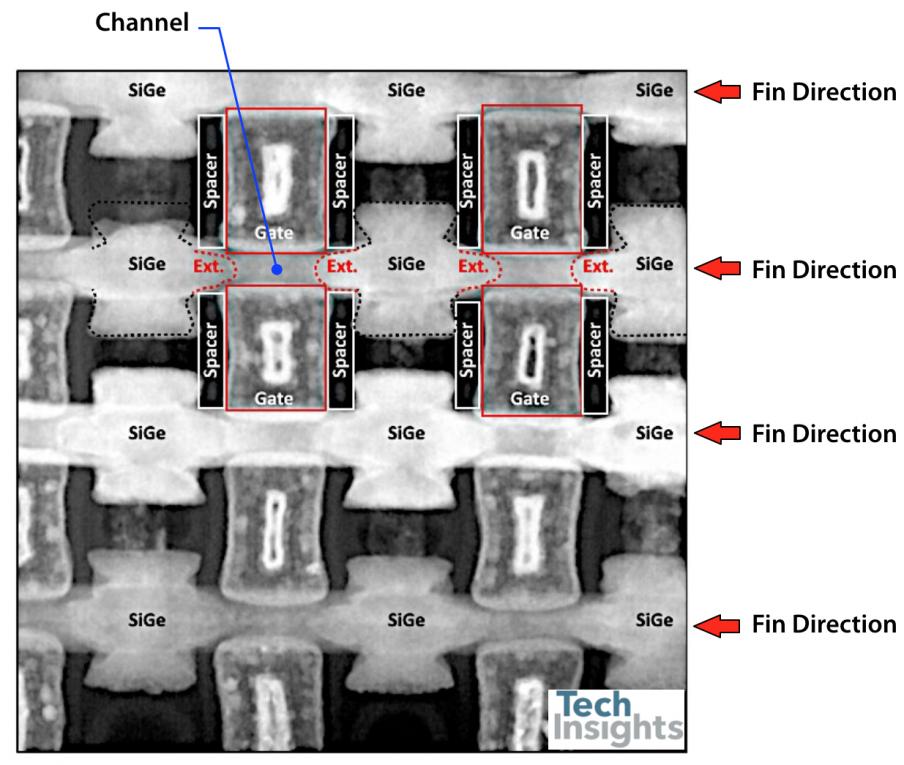

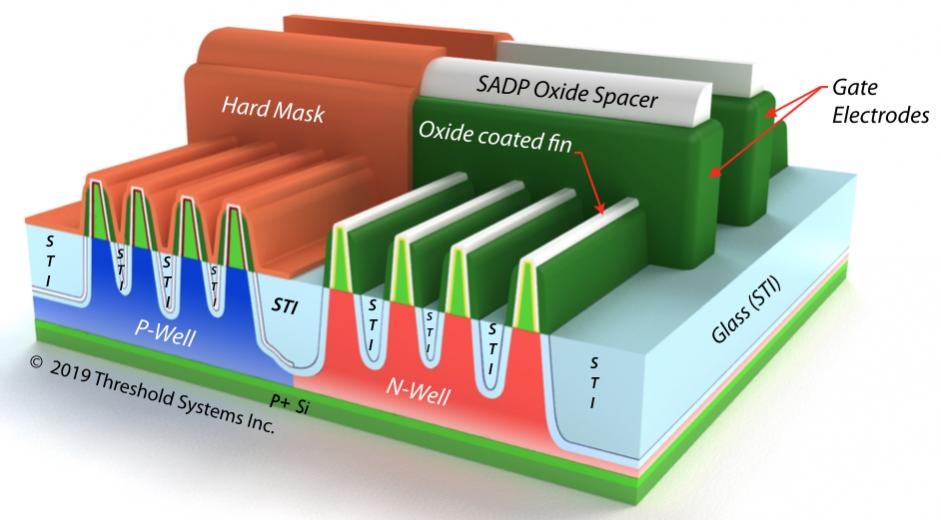





Comments
One Reply to “The Evolution of the Extension Implant Part V”
You must register or log in to view/post comments.