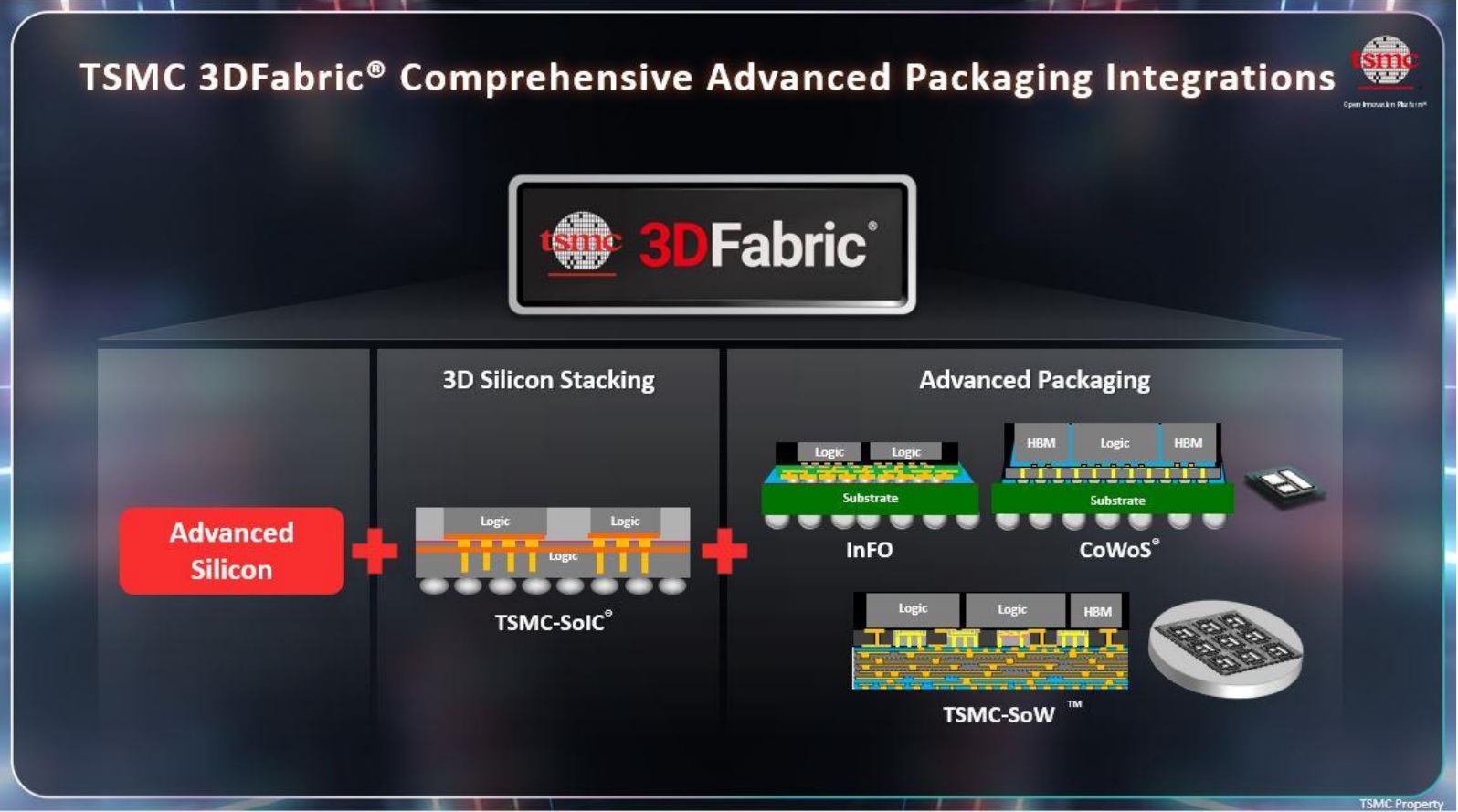
In a significant milestone for the semiconductor industry, Teradyne was honored as the 2025 TSMC Open Innovation Platform® Partner of the Year for TSMC 3DFabric® Testing. This award, announced on September 25, 2025, underscores the deep collaboration between Teradyne, a leader in automated test equipment and robotics, and TSMC, the world’s premier semiconductor foundry. The recognition highlights their joint efforts in advancing multi-die test methodologies for chiplets and TSMC’s CoWoS® advanced packaging technology, marking a pivotal step in the shift toward chiplet-based architectures essential for AI and high-performance computing.
Teradyne, headquartered in North Reading, Massachusetts, specializes in designing and manufacturing automated test solutions for semiconductors, electronics, and robotics systems. Its portfolio ensures high-quality performance across complex devices, from wafer-level testing to final assembly. TSMC dominates the foundry market with cutting-edge process nodes and packaging innovations. The partnership traces back to at least 1999, when TSMC adopted Teradyne’s automatic test equipment for 0.18-micron test chips. Over the years, this alliance has evolved, with Teradyne contributing to TSMC’s ecosystem through innovations in test strategies for heterogeneous integration.
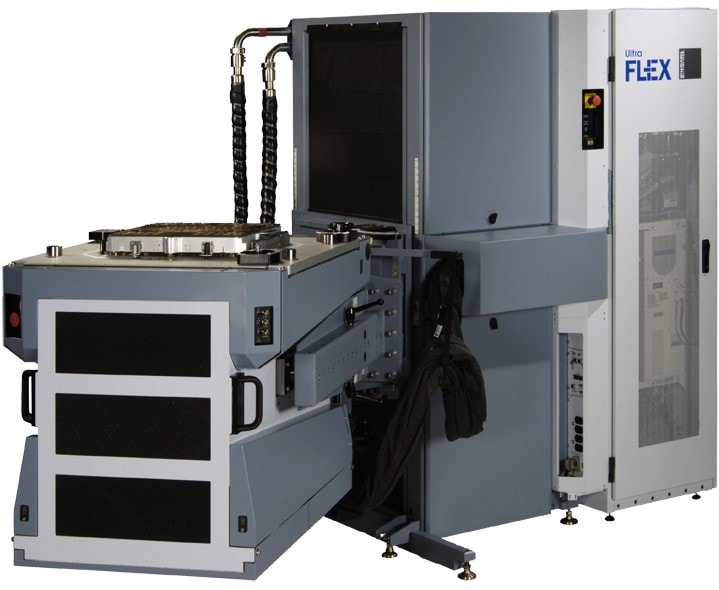
At the heart of this award is TSMC’s OIP, launched in 2008 to foster collaboration among design partners, IP providers, and ecosystem members. OIP accelerates innovation by integrating process technology, EDA tools, and IP, enabling faster implementation of advanced designs. Celebrating its 15th anniversary in 2023, OIP has grown from 65nm nodes onward, addressing rising design complexities. Within this framework, the 3DFabric Alliance, introduced in 2023, focuses on overcoming challenges in 3D integration and advanced packaging.
TSMC 3DFabric® represents a comprehensive suite of 3D silicon stacking and advanced packaging technologies, encompassing both 2.5D and 3D architectures like CoWoS and InFO. These enable heterogeneous integration, boosting system-level performance, power efficiency, and form factors for applications in AI accelerators, 5G, and HPC. CoWoS, in particular, supports multi-die packages by stacking chips on silicon interposers, ideal for demanding AI workloads.
Through the 3DFabric Alliance, Teradyne and TSMC have pioneered test methodologies that enhance silicon bring-up efficiency and test quality. Teradyne’s investments in UCIe, GPIO, and streaming scan test solutions facilitate scalable, high-quality testing of die-to-die interfaces. UCIe, an open standard for chiplet interconnects, ensures seamless data transfer between dies, while streaming scan enables high-speed testing over these interfaces at wafer sort or probing stages. This reduces defect escapes, lowers quality costs, and accelerates time-to-market for 3D ICs used in AI and cloud datacenters.
Shannon Poulin, President of Teradyne’s Semiconductor Test Group, emphasized the value of TSMC’s collaborative ecosystem: “At Teradyne, we strongly believe in the open and collaborative ecosystem approach of TSMC’s Open Innovation Platform and look forward to continuing our partnership to drive innovation and deliver exceptional value to our customers.” Aveek Sarkar, Director of TSMC’s Ecosystem and Alliance Management Division, congratulated Teradyne, noting their contributions to improving silicon bring-up and enabling AI proliferation through energy-efficient compute.
The award was unveiled at the 2025 TSMC North America OIP Ecosystem Forum in Santa Clara, California, on September 24, 2025. This event gathered industry leaders to explore AI’s role in next-generation designs for TSMC’s advanced nodes like A16, N2, and N3. Highlights included discussions on AI-accelerated chip design, multi-die systems, and 3DFabric advancements, with partners showcasing tools for HPC and energy efficiency.
This partnership not only strengthens Teradyne’s position in AI hardware testing but also propels the industry toward more efficient, scalable semiconductor solutions. As demand for AI and cloud infrastructure surges, collaborations like this will be crucial in shortening development cycles and enhancing reliability. Looking ahead, Teradyne and TSMC’s ongoing innovations promise to redefine heterogeneous integration, driving the next wave of technological breakthroughs
Also Read:
Synopsys and TSMC Unite to Power the Future of AI and Multi-Die Innovation
Analog Bits Steps into the Spotlight at TSMC OIP
Share this post via:





Comments
There are no comments yet.
You must register or log in to view/post comments.