Our good friend Scotten Jones wrote a paper on a product that has been in joint development with Synopsys and is now available. Scott is currently President Semiconductor Manufacturing Economics and Senior Fellow at TechInsights. Scott and I have discussed this product many times and I feel it is ground breaking technology for… Read More
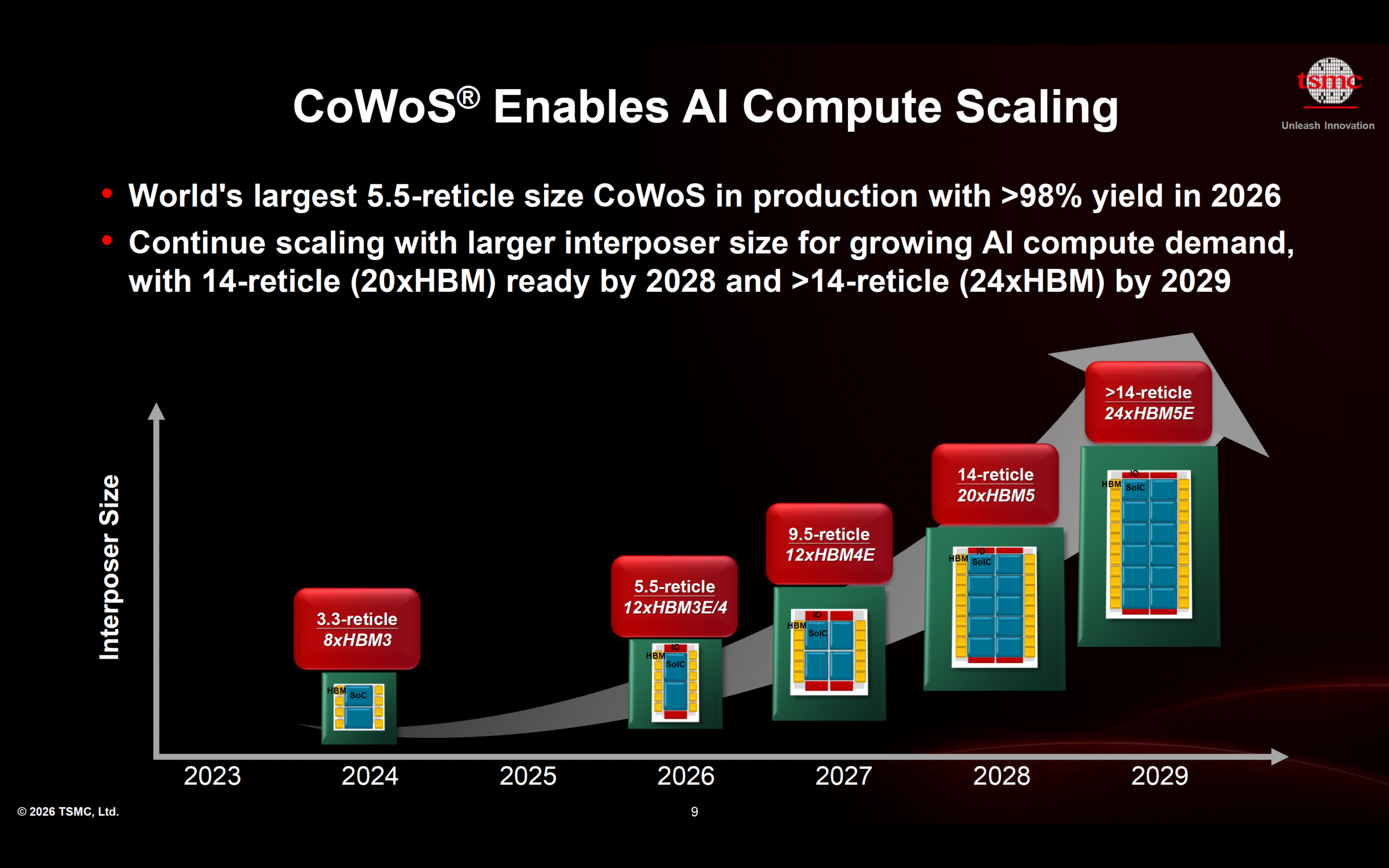 Enabling Next-Generation AI Through Advanced Packaging and 3D Fabric IntegrationThe rapid rise of artificial intelligence is fundamentally…Read More
Enabling Next-Generation AI Through Advanced Packaging and 3D Fabric IntegrationThe rapid rise of artificial intelligence is fundamentally…Read MoreQuantum Computing Technologies and Challenges
There’s more than one way to build a quantum computer (QC) though it took me a while to find a good reference. I finally settled on Building Quantum Computers: A Practical Introduction. Excellent book but designed only for those who will enjoy lots of quantum math. I’m going to spare you that and instead describe a couple of the more… Read More
3D ESD verification: Tackling new challenges in advanced IC design
By Dina Medhat
Three key takeaways
- 3D ICs require fundamentally new ESD verification strategies. Traditional 2D approaches cannot address the complexity and unique connections in stacked-die architectures.
- Classifying external and internal IOs is essential for robust and cost-efficient ESD protection. Proper differentiation
Navigating SoC Tradeoffs from IP to Ecosystem
Building a complex SoC is a risky endeavor that demands careful planning, strategic decisions, and collaboration across hardware and software domains. As highlighted in Darren Jones’ RISC-V Summit presentation from Andes Technology, titled “From Blueprint to Reality: Navigating SoC Tradeoffs, IP, and Ecosystem,”… Read More
Reimagining Architectural Exploration in the Age of AI
This is not about architecting a full SoC from scratch. You already have a competitive platform, now you want to add some kind of accelerator, maybe video, audio, ML, and need to explore architectural options for how accelerator and software should be partitioned, and to optimize PPA. Now we have AI to help us optimize you’d like … Read More
S2C, MachineWare, and Andes Introduce RISC-V Co-Emulation Solution to Accelerate Chip Development
MachineWare, and Andes Technology today announced a collaborative co-emulation solution designed to address the increasing complexity of RISC-V-based chip design. The solution integrates MachineWare’s SIM-V virtual platform, S2C’s Genesis Architect and Prodigy FPGA Prototyping Systems, and Andes’ high-performance… Read More
Aerial 5G Connectivity: Feasibility for IoT and eMBB via UAVs
In the evolving landscape of telecommunications, uncrewed aerial vehicles (UAVs) are emerging as innovative platforms for extending 5G networks, particularly in areas lacking terrestrial infrastructure. Dr. Jyrki T. J. Penttinen’s paper, presented at the First International Conference on AI-enabled Unmanned … Read More
A Webinar About Electrical Verification – The Invisible Bottleneck in IC Design
Electrical rule checking (ERC) is a standard part of any design flow. There is a hidden problem with the traditional approach, however. As designs grow in complexity, whether full-custom analog, mixed-signal, or advanced-node digital, the limitations of traditional ERC tools are becoming more problematic. This can lead to… Read More
Signal Integrity Verification Using SPICE and IBIS-AMI
High-speed signals enable electronic systems by using memory interfaces, SerDes channels, data center backplanes and connectivity in automobiles. Challenges arise from signal distortions like inter-symbol interference, channel loss and dispersion effects. Multi-gigabit data transfer rates in High-Bandwidth Memory… Read More
WEBINAR: Why Network-on-Chip (NoC) Has Become the Cornerstone of AI-Optimized SoCs
By Andy Nightingale, VP of Product Management and Marketing
As AI adoption accelerates across markets, including automotive ADAS, large-scale compute, multimedia, and edge intelligence, the foundations of system-on-chip (SoC) designs are being pushed harder than ever. Modern AI engines generate tightly coordinated, … Read More








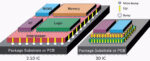






Solving the EDA tool fragmentation crisis