It is now time for the EUV community to realize they are caught between the proverbial Scylla and Charybdis. In Greek mythology, the two monsters terrorized ships that were unlucky enough to pass between them. By avoiding one, you approached the other.
S for Scylla, or Stochastics
Scylla was a former beautiful nymph turned into


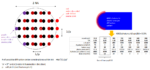



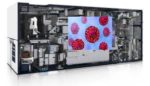



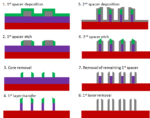

Silicon Insurance: Why eFPGA is Cheaper Than a Respin — and Why It Matters in the Intel 18A Era