In a major announcement at the 2025 Design Automation Conference (DAC), Siemens EDA introduced a significant expansion to its electronic design automation (EDA) portfolio, aimed at transforming how engineers design, validate, and manage the complexity of next-generation three-dimensional integrated circuits (3D ICs).… Read More
 imec IC-Link and TSMC 3DFabric Alliance Expansion Signals New Era of System-Level Scalingimec announced that IC-Link by imec has joined…Read More
imec IC-Link and TSMC 3DFabric Alliance Expansion Signals New Era of System-Level Scalingimec announced that IC-Link by imec has joined…Read More From the Selfie to Samantha: The Next Trillion-Dollar BehaviorAt CES 2026, Samsung called it a “companion.”…Read More
From the Selfie to Samantha: The Next Trillion-Dollar BehaviorAt CES 2026, Samsung called it a “companion.”…Read More TSMC’s Record Tool Orders Hint at Another CapEx ShockwaveTSMC’s latest Board of Directors capital appropriation announcement…Read More
TSMC’s Record Tool Orders Hint at Another CapEx ShockwaveTSMC’s latest Board of Directors capital appropriation announcement…Read More CEO Interview with Nagesh Gupta of llmda.aiNagesh has built a career spanning multiple aspects…Read More
CEO Interview with Nagesh Gupta of llmda.aiNagesh has built a career spanning multiple aspects…Read MoreCEO Interview with Faraj Aalaei of Cognichip
Faraj Aalaei is a successful visionary entrepreneur with over 40 years of distinguished experience in communications and networking technologies. As a leading entrepreneur in Silicon Valley, Faraj was responsible for building and leading two semiconductor companies through IPOs as a founder and CEO.
Post acquisition of … Read More
Rethink Scoreboards to Supercharge AI-Era CPUs
By Dr. Thang Minh Tran, CEO/CTO Simplex Micro
Today’s AI accelerators—whether built for massive data centers or low-power edge devices—face a common set of challenges: deep pipelines, complex data dependencies, and the high cost of speculative execution. These same concerns have long been familiar in high-frequency microprocessor… Read More
CEO Interview with Dr. Noah Sturcken of Ferric
Noah Sturcken is a Founder and CEO of Ferric with over 40 patents issued and 15 publications on Integrated Voltage Regulators. Noah leads Ferric with focus on business development, marketing and new technology development. Noah previously worked at AMD R&D Lab where he developed Integrated Voltage Regulator (IVR) technology.… Read More
Jitter: The Overlooked PDN Quality Metric
Bruce Caryl is a Product Specialist with Siemens EDA
The most common way to evaluate a power distribution network is to look at its impedance over the effective frequency range. A lower impedance will produce less noise when transient current is demanded by the IC output buffers. However, this transient current needs to be provided… Read More
Facing the Quantum Nature of EUV Lithography
The topics of stochastics and blur in EUV lithography has been examined by myself for quite some time now [1,2], but I am happy to see that others are pursuing this direction seriously as well [3]. As advanced node half-pitch dimensions approach 10 nm and smaller, the size of molecules in the resist becomes impossible to ignore for… Read More
Podcast EP294: An Overview of the Momentum and Breadth of the RISC-V Movement with Andrea Gallo
Dan is joined by Andrea Gallo, CEO of RISC-V International, the non-profit home of the RISC-V instruction set architecture standard, related specifications, and stakeholder community. Prior to joining RISC-V International, Gallo worked in leadership roles at Linaro for over a decade. He built Linaro’s server engineering… Read More
Silvaco’s Diffusion of Innovation: Ecosystem Investments Driving Semiconductor Advancements
In Silvaco’s June 2025 Tech Talk, “The Diffusion of Innovation: Investing in the Ecosystem Expansion,” Chief Revenue Officer Ian Chen outlined how strategic partnerships accelerate R&D in semiconductor design and digital twin modeling. As a leading provider of TCAD, EDA software, and SIP solutions,… Read More
CEO Interview with Vamshi Kothur, of Tuple Technologies
It was my pleasure to meet with Vamshi Kothur and the Tuple team at #62DAC for a briefing on their Tropos platform and Omni, a new multi-cloud optimizer. The conferences this year have been AI infused with exciting new technologies but one of the lingering questions is: How will the existing semiconductor design IT infrastructure… Read More
Webinar – Power is the New Performance: Scaling Power & Performance for Next Generation SoCs
What if you could reduce power and extend chip lifetime, without compromising performance? We all know the importance of power optimization for advanced SoCs. Thanks to the massive build out of AI workloads, power consumption has gone from a cost or cooling headache to an existential threat to the planet, if current power consumptions… Read More




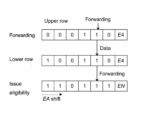






Crossing the Yield Cliff: IDP V6 and the Future of Manufacturing Forecasting