Threads
XF\Mvc\Entity\ArrayCollection Object
(
[entities:protected] => Array
(
[25076] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 57
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25076
[node_id] => 2
[title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[reply_count] => 11
[view_count] => 616
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778548540
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99798
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778600633
[last_post_id] => 99837
[last_post_user_id] => 38088
[last_post_username] => Brady
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25074] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 61
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25074
[node_id] => 2
[title] => Cerebras to raise IPO price range to $150-$160 as demand surges, sources say
[reply_count] => 7
[view_count] => 427
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778511949
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99783
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778599916
[last_post_id] => 99836
[last_post_user_id] => 16791
[last_post_username] => lefty
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25025] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 65
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25025
[node_id] => 2
[title] => Intel Prepares HBM Killer: HB3DM Memory Stacks with Z-Angle Technology
[reply_count] => 13
[view_count] => 2610
[user_id] => 332041
[username] => XYang2023
[post_date] => 1777512302
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99556
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1778595949
[last_post_id] => 99834
[last_post_user_id] => 5185
[last_post_username] => Fred Chen
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 62
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 332041
[username] => XYang2023
[username_date] => 0
[username_date_visible] => 0
[email] => xiao.yang17@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Australia/Sydney
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1388
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1708819075
[last_activity] => 1778321803
[last_summary_email_date] => 1771165277
[trophy_points] => 113
[alerts_unviewed] => 1
[alerts_unread] => 1
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 867
[warning_points] => 0
[is_staff] => 0
[secret_key] => NBs1n4BMtljiqSmfC-EZI_MMUn9Rzevl
[privacy_policy_accepted] => 1708819075
[terms_accepted] => 1708819075
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25075] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 69
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25075
[node_id] => 2
[title] => AI Anthropic settles for $1.5B for copyrighted works of book authors
[reply_count] => 2
[view_count] => 192
[user_id] => 35301
[username] => Xebec
[post_date] => 1778531970
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99793
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778589007
[last_post_id] => 99832
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 66
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 35301
[username] => Xebec
[username_date] => 0
[username_date_visible] => 0
[email] => john.heritage@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1733
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1598710106
[last_activity] => 1778596718
[last_summary_email_date] => 1631629203
[trophy_points] => 113
[alerts_unviewed] => 2
[alerts_unread] => 3
[avatar_date] => 1760746858
[avatar_width] => 480
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 2111
[warning_points] => 0
[is_staff] => 0
[secret_key] => Y7XyJgQMBi7ZiDtuAyqNGDrBQQsi8JB4
[privacy_policy_accepted] => 1598710106
[terms_accepted] => 1598710106
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25093] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 73
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25093
[node_id] => 2
[title] => TSMC Flags Four Key Challenges in Arizona Buildout Even as U.S. Fab Beats Expectations
[reply_count] => 1
[view_count] => 123
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778581432
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99830
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778583618
[last_post_id] => 99831
[last_post_user_id] => 16950
[last_post_username] => benb
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[23542] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 77
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 23542
[node_id] => 2
[title] => VSMC - New FAB going up in Singapore [Video]
[reply_count] => 6
[view_count] => 2514
[user_id] => 20231
[username] => Barnsley
[post_date] => 1757050231
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 91549
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1778581387
[last_post_id] => 99829
[last_post_user_id] => 20231
[last_post_username] => Barnsley
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 74
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 20231
[username] => Barnsley
[username_date] => 0
[username_date_visible] => 0
[email] => apickering72@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Irkutsk
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1465
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1429440429
[last_activity] => 1778595148
[last_summary_email_date] => 1653315673
[trophy_points] => 113
[alerts_unviewed] => 9
[alerts_unread] => 9
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 763
[warning_points] => 0
[is_staff] => 0
[secret_key] => iAnkz9GTDfivRmH1BOp6OTrgESJR57G8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25092] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 81
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25092
[node_id] => 2
[title] => SK Hynix Pursues Collaboration with Intel on 2.5D Packaging Signaling Changes in AI Chip Supply Chain
[reply_count] => 0
[view_count] => 145
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778580705
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99827
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778580705
[last_post_id] => 99827
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25017] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 85
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25017
[node_id] => 2
[title] => Industry faces “acute” CPU shortage with hope that Intel 18A yields improve
[reply_count] => 34
[view_count] => 6199
[user_id] => 5185
[username] => Fred Chen
[post_date] => 1777451029
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99529
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1778580417
[last_post_id] => 99826
[last_post_user_id] => 16950
[last_post_username] => benb
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 82
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5185
[username] => Fred Chen
[username_date] => 0
[username_date_visible] => 0
[email] => chen.t.fred@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 4
[secondary_group_ids] =>
[display_style_group_id] => 4
[permission_combination_id] => 92
[message_count] => 2640
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1333032401
[last_activity] => 1778595949
[last_summary_email_date] => 1605940563
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 1
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 1938
[warning_points] => 0
[is_staff] => 0
[secret_key] => 5m-bZq0HRSi9VA-96QONHJeevdQas5S8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25091] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 89
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25091
[node_id] => 2
[title] => TSMC Board of Directors Meeting Resolutions May 12, 2026
[reply_count] => 0
[view_count] => 145
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778578853
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99824
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778578853
[last_post_id] => 99824
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25072] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 93
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25072
[node_id] => 2
[title] => Intel CEO Who Won Over Trump and Musk Now Needs a Breakthrough
[reply_count] => 7
[view_count] => 1818
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778312880
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99761
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778550324
[last_post_id] => 99803
[last_post_user_id] => 38697
[last_post_username] => blueone
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25043] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 97
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25043
[node_id] => 2
[title] => Apple in Talks with Intel, Samsung for US Chipmaking
[reply_count] => 10
[view_count] => 1936
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778001275
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99673
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778549148
[last_post_id] => 99800
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25066] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 101
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25066
[node_id] => 2
[title] => TSMC eyes bigger US investment; Arizona chip expansion accelerates
[reply_count] => 1
[view_count] => 1187
[user_id] => 19450
[username] => user nl
[post_date] => 1778209638
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99745
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778493029
[last_post_id] => 99782
[last_post_user_id] => 443620
[last_post_username] => reviously
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 98
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 1
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 590
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1778581588
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 2
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 435
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25073] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 105
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25073
[node_id] => 2
[title] => Global semiconductor market faces shortages as AI demand strains supply chains
[reply_count] => 1
[view_count] => 1402
[user_id] => 19450
[username] => user nl
[post_date] => 1778337105
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99768
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778487535
[last_post_id] => 99781
[last_post_user_id] => 441563
[last_post_username] => aptable
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 98
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 1
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 590
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1778581588
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 2
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 435
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25062] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 109
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25062
[node_id] => 2
[title] => Elon Musk lays out Terafab AI chip project plan
[reply_count] => 14
[view_count] => 3269
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778081191
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99711
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778438975
[last_post_id] => 99780
[last_post_user_id] => 19450
[last_post_username] => user nl
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25068] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 113
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25068
[node_id] => 2
[title] => SK Hynix customers offering to buy EUV machines..
[reply_count] => 3
[view_count] => 1500
[user_id] => 35301
[username] => Xebec
[post_date] => 1778255418
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99749
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778321871
[last_post_id] => 99765
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 66
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 35301
[username] => Xebec
[username_date] => 0
[username_date_visible] => 0
[email] => john.heritage@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1733
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1598710106
[last_activity] => 1778596718
[last_summary_email_date] => 1631629203
[trophy_points] => 113
[alerts_unviewed] => 2
[alerts_unread] => 3
[avatar_date] => 1760746858
[avatar_width] => 480
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 2111
[warning_points] => 0
[is_staff] => 0
[secret_key] => Y7XyJgQMBi7ZiDtuAyqNGDrBQQsi8JB4
[privacy_policy_accepted] => 1598710106
[terms_accepted] => 1598710106
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25071] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 117
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25071
[node_id] => 2
[title] => Apple, Intel Have Reached Preliminary Chip-Making Agreement WSJ
[reply_count] => 0
[view_count] => 2089
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778273609
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99758
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778273609
[last_post_id] => 99758
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25070] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 121
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25070
[node_id] => 2
[title] => TSMC April 2026 Revenue Report
[reply_count] => 1
[view_count] => 1601
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1778255758
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99751
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1778256001
[last_post_id] => 99752
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15549
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1778581437
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 83
[alerts_unread] => 83
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9430
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25069] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 125
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25069
[node_id] => 2
[title] => As Memory Prices Soar, Will Phison's "Budget AI" Become the Laptop Standard?
[reply_count] => 0
[view_count] => 723
[user_id] => 398583
[username] => karin623
[post_date] => 1778255471
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99750
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778255471
[last_post_id] => 99750
[last_post_user_id] => 398583
[last_post_username] => karin623
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 122
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 398583
[username] => karin623
[username_date] => 0
[username_date_visible] => 0
[email] => karin623@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Hong_Kong
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 46
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1748753435
[last_activity] => 1778255472
[last_summary_email_date] => 1771856462
[trophy_points] => 18
[alerts_unviewed] => 4
[alerts_unread] => 4
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 66
[warning_points] => 0
[is_staff] => 0
[secret_key] => PBnrLVmUtkEL7YUKL8Ij_6L3tfKYRzDQ
[privacy_policy_accepted] => 1748753435
[terms_accepted] => 1748753435
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24989] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 129
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24989
[node_id] => 2
[title] => South Korea’s K-shaped economy where chip giants give out $1 million bonuses to staff
[reply_count] => 29
[view_count] => 3305
[user_id] => 20231
[username] => Barnsley
[post_date] => 1777001445
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99412
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1778178287
[last_post_id] => 99743
[last_post_user_id] => 38697
[last_post_username] => blueone
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 74
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 20231
[username] => Barnsley
[username_date] => 0
[username_date_visible] => 0
[email] => apickering72@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Irkutsk
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1465
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1429440429
[last_activity] => 1778595148
[last_summary_email_date] => 1653315673
[trophy_points] => 113
[alerts_unviewed] => 9
[alerts_unread] => 9
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 763
[warning_points] => 0
[is_staff] => 0
[secret_key] => iAnkz9GTDfivRmH1BOp6OTrgESJR57G8
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[25056] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 133
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 25056
[node_id] => 2
[title] => AMD lifts outlook as AI demand fuels data center growth
[reply_count] => 5
[view_count] => 1524
[user_id] => 19450
[username] => user nl
[post_date] => 1778036361
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 99692
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1778166828
[last_post_id] => 99735
[last_post_user_id] => 35301
[last_post_username] => Xebec
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 98
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 1
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 590
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1778581588
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 2
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 435
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8611
[message_count] => 62980
[last_post_id] => 99837
[last_post_date] => 1778600633
[last_post_user_id] => 38088
[last_post_username] => Brady
[last_thread_id] => 25076
[last_thread_title] => Intel’s stock tripled under Lip-Bu Tan. He still has not told most employees the plan.
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[populated:protected] => 1
)
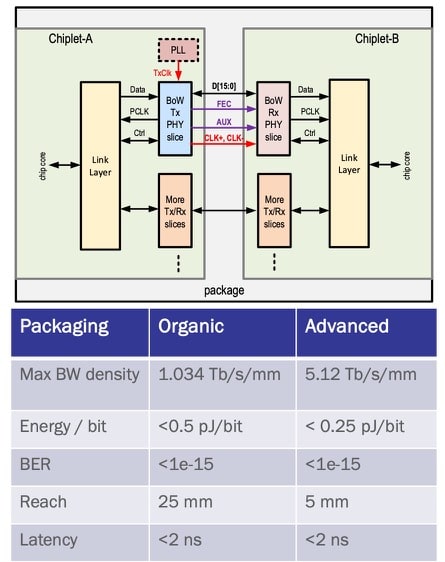
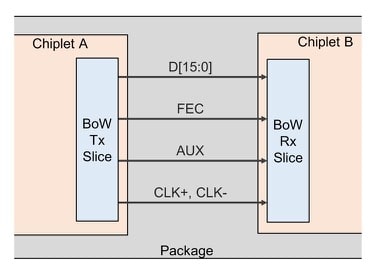
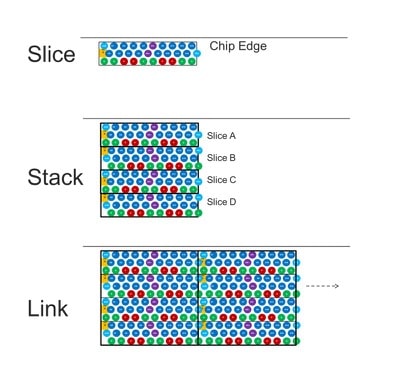
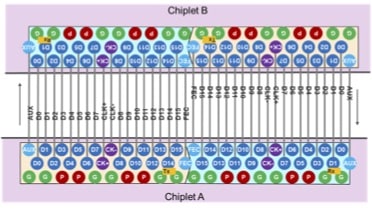






Comments
One Reply to “Die-to-Die Interconnects using Bunch of Wires (BoW)”
You must register or log in to view/post comments.