There has been much interest in Huawei’s and SMIC’s plans for 5nm production in the near future. Since there is no use of EUV in China, immersion DUV lithography (with a 76 nm pitch resolution) is expected to be used along with pitch quartering to achieve pitches in the 20-30 nm range expected for the 5nm and 3nm nodes [1].… Read More
ASML- Soft revenues & Orders – But…China 49% – Memory Improving
ASML- better EPS but weaker revenues- 2024 recovery on track
China jumps 10% to 49%- Memory looking better @59% of orders
Order lumpiness increases with ASP- EUV will be up-DUV down
“Passing Bottom” of what has been a long down cycle
Weak revenues & orders but OK EPS
Reported revenue was Euro5.3B and EPS of Euro3.11… Read More
TSMC and Synopsys Bring Breakthrough NVIDIA Computational Lithography Platform to Production
NVIDIA cuLitho Accelerates Semiconductor Manufacturing’s Most Compute-Intensive Workload by 40-60x, Opens Industry to New Generative AI Algorithms.
An incredible example of semiconductor industry partnerships was revealed during the Synopsys User Group (SNUG) last month. It started with a press release but there is much… Read More
Measuring Local EUV Resist Blur with Machine Learning
Resist blur remains a topic that is relatively unexplored in lithography. Blur has the effect of reducing the difference between the maximum and minimum doses in the local region containing the feature. Blur is particularly important for EUV lithography since EUV lithography is prone to stochastic fluctuations and also driven… Read More
Pinning Down an EUV Resist’s Resolution vs. Throughput
The majority of EUV production is on 5nm and 3nm node, implemented by late 2022. Metal oxide resists have not been brought into volume production yet [1,2], meaning that only organic chemically amplified resists (CARs) have been used instead until now. These resists have a typical absorption coefficient of 5/um [3,4], which means
Application-Specific Lithography: Avoiding Stochastic Defects and Image Imbalance in 6-Track Cells
The discussion of any particular lithographic application often refers to imaging a single pitch, e.g., 30 nm pitch for a 5nm-family track metal scenario. However, it is always necessary to confirm the selected patterning techniques on the actual use case. The 7nm, 5nm, or 3nm 6-track cell has four minimum pitch tracks, flanked… Read More
Non-EUV Exposures in EUV Lithography Systems Provide the Floor for Stochastic Defects in EUV Lithography
EUV lithography is a complicated process with many factors affecting the production of the final image. The EUV light itself doesn’t directly generate the images, but acts through secondary electrons which are released as a result of ionization by incoming EUV photons. Consequently, we need to be aware of the fluctuations… Read More
Application-Specific Lithography: Sense Amplifier and Sub-Wordline Driver Metal Patterning in DRAM
On a DRAM chip, the patterning of features outside the cell array can be just as challenging as those within the array itself. While the array contains features which are the most densely packed, at least they are regularly arranged. On the other hand, outside the array, the regularity is lost, but the in the most difficult cases, … Read More
Is Intel cornering the market in ASML High NA tools? Not repeating EUV mistake
- Reports suggest Intel will get 6 of 10 ASML High NA tools in 2024
- Would give Intel a huge head start over TSMC & Samsung
- A big gamble but a potentially huge pay off
- Does this mean $4B in High NA tool sales for ASML in 2024?
News suggests Intel will get 6 of first 10 High NA tools made by ASML in 2024
An industry news source, Trendforce, reports… Read More
BEOL Mask Reduction Using Spacer-Defined Vias and Cuts
In recent advanced nodes, via and cut patterning have constituted a larger and larger portion of the overall BEOL mask count. The advent of SALELE [1,2] caused mask count to increase for EUV as well, resulting in costs no longer being competitive with DUV down to 3nm [3]. Further development by TEL [4] has shown the possibility for… Read More



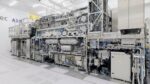
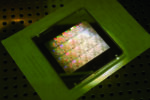






Is Intel About to Take Flight?