You are currently viewing SemiWiki as a guest which gives you limited access to the site. To view blog comments and experience other SemiWiki features you must be a registered member. Registration is fast, simple, and absolutely free so please,
join our community today!
An update is now available here: Application-Specific Lithography: Patterning 5nm 5.5-Track Metal by DUV
The 5nm foundry (e.g., TSMC) node may see the introduction of 6-track cells (two double-width rails plus four minimum-width dense lines) with a minimum metal pitch in the neighborhood of 30 nm. IMEC had studied a representative… Read More
The stochastic nature of imaging has received a great deal of attention in the area of EUV lithography. The density of EUV photons reaching the wafer is low enough [1] that the natural variation in the number of photons arriving at a given location can give rise to a relatively large standard deviation.
In recent studies [2,3], it … Read More
The overwhelming majority of transistors produced in the world are used in memory cells, either as the memory itself (Flash, SRAM), or as the access device (DRAM). Yet, it is not necessary to have a transistor in every memory cell. In 2015, 3D XPoint, the first major product based on transistor-less memory cells, was announced [1].
…
Read More
Self-aligned quadruple patterning (SAQP) is the most widely available technology used for patterning feature pitches less than 38 nm, with a projected capability to reach 19 nm pitch. It is actually an integration of multiple process steps, already being used to pattern the fins of FinFETs [1] and 1X DRAM [2]. These steps, shown… Read More
Moore’s Law has been about device density, specifically transistor density, increasing every certain number of years. Although cost is the most easily grasped advantage, there are two other benefits: higher performance (speed) and reduced power. When these benefits are compromised, they can also pose a scaling limitation.
…
Read More
EUV (Extreme UltraViolet) lithography has received attention within the semiconductor industry since its development inception in 1997 with the formation of the EUV LLC [1], and more recently, since the 7nm node began, with limited use by Samsung and TSMC being touted as key advantages [2, 3]. As with any key critical technology,
…
Read More
As transistor dimensions shrink to follow Moore’s Law, the functionality of the gate used to switch on or off the current is actually being degraded by the short channel effect (SCE) [1-5]. Moreover, the simultaneous reduction of voltage aggravates the degradation, as will be discussed below.
A Practical Lower Limit of… Read More
Spacer-defined patterning is an expected requirement for advanced semiconductor patterning nodes with feature sizes of 25 nm or less. As the required gaps between features go well below the lithography tool’s resolution limit, the use of cut exposures to separate features is used more often, especially in chips produced… Read More
In a previous article [1], the Rayleigh criterion was mentioned as the resolution limit for the distance between two features. On the other hand, in a following article [2], the minimum pitch was mentioned for the resolution limit for arrayed features. In this article, we reconcile the two by considering gaps between arrayed features,… Read More
State-of-the-art chips will always include some portions which are memory arrays, which also happen to be the densest portions of the chip. Arrayed features are the main targets for lithography evaluation, as the feature pitch is well-defined, and is directly linked to the cost scaling (more features per wafer) from generation… Read More






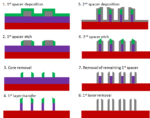

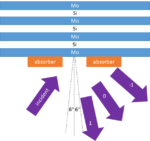



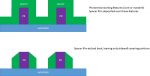







Intel, Musk, and the Tweet That Launched a 1000 Ships on a Becalmed Sea