The first article in this series examined how feasibility exploration enables architects to evaluate multi-die system configurations while minimizing early design risk. Once architectural decisions are validated, designers must translate conceptual connectivity requirements into physical interconnect infrastructure.… Read More
Designing the Future: AI-Driven Multi-Die Innovation in the Era of Agentic Engineering
At the 2026 Chiplet Summit, Synopsys presented a bold vision for the future of semiconductor innovation: AI-driven multi-die design powered by agentic intelligence. As the semiconductor industry shifts rapidly toward chiplet-based architectures and 3D stacking, the complexity of design, verification, and system integration… Read More
Accelerating Static ESD Simulation for Full-Chip and Multi-Die Designs with Synopsys PathFinder-SC
As analog and mixed-signal designs become increasingly complex, parasitic effects dominate both design time and cost, consuming 30–50% of engineers’ effort in debugging and reanalyzing circuits. Addressing these multiphysics effects requires early verification strategies and reliable simulation solutions. Modern … Read More
Silicon Catalyst at the Chiplet Summit: Advancing the Chiplet Economy
The rapid evolution of semiconductor design has elevated chiplets from a niche concept to a foundational strategy for next-generation computing. At the upcoming Chiplet Summit – February 17–19, 2026 Santa Clara Convention Center. Silicon Catalyst will play a central role in shaping this conversation, highlighting… Read More
DAC – The Chips to Systems Conference 2026
The Design Automation Chips to Systems Conference is the preeminent international event for professionals involved in electronic design, system architecture, and EDA. Formerly known simply as the Design Automation Conference or DAC has evolved over more than six decades into a forward-looking forum that spans the entire… Read More
Hierarchical Device Planning as an Enabler of System Technology Co-Optimization
AI, hyperscale data centers, and data-intensive workloads are driving unprecedented demands for performance, bandwidth, and energy efficiency. As the economic returns of traditional transistor scaling diminish, advanced IC packaging and heterogeneous integration have become the primary levers for system-level scaling.… Read More
Arteris Smart NoC Automation: Accelerating AI-Ready SoC Design in the Era of Chiplets
As semiconductor design pushes into increasingly complex territory, driven by Ai, ML, HPC, and heterogeneous system architectures, designers are challenged to balance performance, power, and time-to-market pressures. In this landscape, network-on-chip (NoC) architectures have emerged as a foundational building block… Read More
2026 Outlook with Nilesh Kamdar of Keysight EDA
Tell us a little bit about yourself and your company.
I’m Nilesh Kamdar, General Manager of the Keysight EDA business unit. Keysight is an S&P 500 company that provides design, emulation, and test solutions to help engineers develop and deploy faster with less risk. On the EDA side, we focus on RFMW, high-speed digital,… Read More
Podcast EP323: How to Address the Challenges of 3DIC Design with John Ferguson
Daniel is joined by John Ferguson, senior director of product management for the Calibre products in the 3DIC space at Siemens EDA. He manages the vision and product offerings in the Calibre domain for 3DIC design solutions.
Dan explores the challenges of 3DIC and chiplet-based design with John, who describes the broad range of… Read More
MZ Technologies Launches Advanced Packaging Design Video Series
In a significant move aimed at empowering semiconductor and systems-design engineers, MZ Technologies has announced the launch of a new video series focused on advanced packaging design. This initiative comes at a time when the semiconductor industry is rapidly shifting toward multi-die, 2.5D/3D integration, heterogeneous… Read More


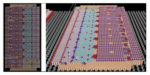



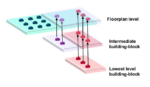


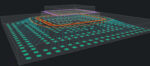
Is Intel About to Take Flight?