A recent announcement from Synopsys signals a meaningful escalation in the race to build next-generation AI hardware. The expanded collaboration between Synopsys and TSMC brings together silicon-proven IP, AI-driven design tools, and cutting-edge manufacturing processes in a tightly integrated effort to accelerate high-performance… Read More
Enabling Next-Generation AI Through Advanced Packaging and 3D Fabric Integration
The rapid rise of artificial intelligence is fundamentally reshaping computing architectures. As AI models scale toward trillions of parameters, traditional approaches to performance improvement are no longer sufficient. Instead, the industry is entering a new era where system-level innovation, advanced packaging, … Read More
The Shift to System-Level AI Drives Next-Generation Silicon
At its 2026 Technology Symposium, TSMC delivered a clear message: the AI era has entered a new phase. The primary constraint is no longer model capability, but the systems required to run those models at scale. Addressing this shift will demand significant advances in semiconductor technology, spanning compute, memory, interconnects,… Read More
Closing the Reality Gap: A New Architecture for 1.8-Tb/s Chiplet Governance
Dr. Moh Kolbehdari is a Senior Lead Architect at Socionext, where he specializes in the industrialization of high-performance AI chiplets and 1.8-Tb/s interconnects. With over two decades of experience in SI/PI, electromagnetic field theory, and system-level architecture, he has been a pivotal force in bridging the gap between… Read More
proteanTecs at Chiplet Summit – Changing the Game for Health & Performance Monitoring of Chiplets
The recent Chiplet Summit 2026 was a great place to learn about new chiplet designs, emerging standards, and a growing array of support technologies to help design and manufacture chiplet-based systems. In my travels at the show, I found a lot of technology that fit these descriptions. But there were also companies at the show that… Read More
CEO Interview with Dr. Hardik Kabaria of Vinci
Hardik Kabaria is the founder and CEO of Vinci, a frontier lab building systems that make physical reality continuously computable.
While software has become programmable, physics has remained episodic—accessed through discrete simulations and approximations. Vinci is changing that. Under Kabaria’s leadership, the company
Podcast EP338: How Thermo Fisher Scientific Helps Advanced Semiconductor Development with Dr. Mohan Iyer
Daniel is joined by Dr. Mohan Iyer, who serves as the vice president and general manager of the Semiconductor Business Unit at Thermo Fisher Scientific, a global leader in providing reference metrology, defect characterization, and localization equipment. These advanced systems are essential for driving innovation, accelerating… Read More
Alchip’s Leadership in ASIC Innovation: Advancing Toward 2nm Semiconductor Technology
Alchip Technologies has recently reported significant progress in the development of advanced 2nm ASICs, positioning itself as a leader in next-generation semiconductor design for AI and HPC. The announcement highlights Alchip’s efforts to commercialize cutting-edge chip technologies and deliver highly customized … Read More
Synopsys Advances Hardware Assisted Verification for the AI Era
At the 2026 Synopsys Converge Event, Synopsys announced a broad set of new products and platform upgrades, with its hardware-assisted verification (HAV) announcement emerging as a key highlight within that lineup. A key aspect of this announcement was moving beyond a hardware centric model to a more scalable, programmable … Read More
Scaling Multi-Die Connectivity: Automated Routing for High-Speed Interfaces
This article concludes the three-part series examining key methodologies required for successful multi-die design. The first article Reducing Risk Early: Multi-Die Design Feasibility Exploration focused on feasibility exploration and early architectural validation, while the second article Building the Interconnect… Read More








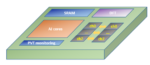

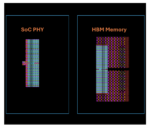
ASML High-NA EUV is Not Ready for High-Volume Production