Threads
XF\Mvc\Entity\ArrayCollection Object
(
[entities:protected] => Array
(
[24852] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 57
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24852
[node_id] => 2
[title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[reply_count] => 0
[view_count] => 80
[user_id] => 19450
[username] => user nl
[post_date] => 1774875154
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98769
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1774875154
[last_post_id] => 98769
[last_post_user_id] => 19450
[last_post_username] => user nl
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 524
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1774883337
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 383
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24846] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 61
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24846
[node_id] => 2
[title] => SoftBank secures $40 billion loan to boost OpenAI investments
[reply_count] => 1
[view_count] => 509
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1774712355
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98749
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774861701
[last_post_id] => 98768
[last_post_user_id] => 16791
[last_post_username] => lefty
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15424
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1774857371
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 92
[alerts_unread] => 92
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9303
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24851] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 65
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24851
[node_id] => 2
[title] => Rapidus Accelerates 1nm Push, Reportedly Targets Six-Month Gap with TSMC
[reply_count] => 0
[view_count] => 167
[user_id] => 19450
[username] => user nl
[post_date] => 1774856912
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98767
[first_post_reaction_score] => 1
[first_post_reactions] => {"3":1}
[last_post_date] => 1774856912
[last_post_id] => 98767
[last_post_user_id] => 19450
[last_post_username] => user nl
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 524
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1774883337
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 383
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24804] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 69
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24804
[node_id] => 2
[title] => Terafab 21 March 2026
[reply_count] => 62
[view_count] => 6808
[user_id] => 19450
[username] => user nl
[post_date] => 1774185410
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98562
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774855892
[last_post_id] => 98766
[last_post_user_id] => 19450
[last_post_username] => user nl
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 524
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1774883337
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 383
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24850] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 73
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24850
[node_id] => 2
[title] => TSMC's 2-Nanometer Sold Out; Samsung Foundry Gains
[reply_count] => 1
[view_count] => 402
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1774822481
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98764
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774823534
[last_post_id] => 98765
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15424
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1774857371
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 92
[alerts_unread] => 92
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9303
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24847] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 77
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24847
[node_id] => 2
[title] => Taiwan Urgent Water Situation Alert! Chief Water Resources Officer
[reply_count] => 3
[view_count] => 634
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1774725793
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98750
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774821666
[last_post_id] => 98763
[last_post_user_id] => 16950
[last_post_username] => benb
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15424
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1774857371
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 92
[alerts_unread] => 92
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9303
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24849] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 81
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24849
[node_id] => 2
[title] => Pat Gelsinger on Jodi Shelton podcast
[reply_count] => 0
[view_count] => 194
[user_id] => 396
[username] => swka
[post_date] => 1774821643
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98762
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1774821643
[last_post_id] => 98762
[last_post_user_id] => 396
[last_post_username] => swka
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 78
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 396
[username] => swka
[username_date] => 0
[username_date_visible] => 0
[email] => swka@hotmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 170
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1294249501
[last_activity] => 1774850535
[last_summary_email_date] => 1686406808
[trophy_points] => 43
[alerts_unviewed] => 7
[alerts_unread] => 7
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 144
[warning_points] => 0
[is_staff] => 0
[secret_key] => OO7IirVdCg0w0g8RomEV2hwUwfXsJgMD
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24822] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 85
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24822
[node_id] => 2
[title] => Arm Releases First Ever AI Chip, With Meta As Initial Customer
[reply_count] => 18
[view_count] => 1692
[user_id] => 36640
[username] => soAsian
[post_date] => 1774384804
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98647
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1774790223
[last_post_id] => 98759
[last_post_user_id] => 38697
[last_post_username] => blueone
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 82
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 36640
[username] => soAsian
[username_date] => 0
[username_date_visible] => 0
[email] => jackmtsai@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Chicago
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 413
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1608139716
[last_activity] => 1774876540
[last_summary_email_date] => 1719670845
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 377
[warning_points] => 0
[is_staff] => 0
[secret_key] => 2oKeCTFkGUpMro5tcmj7WaY9HksB13Kw
[privacy_policy_accepted] => 1608139716
[terms_accepted] => 1608139716
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24848] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 89
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24848
[node_id] => 2
[title] => SemiAnalysis Podcast 27 March 2026: The AI Silicon Shortage Explained: TSMC, Nvidia CPO, Memory Crisis & What Comes Next
[reply_count] => 1
[view_count] => 459
[user_id] => 19450
[username] => user nl
[post_date] => 1774776424
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98755
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774787550
[last_post_id] => 98758
[last_post_user_id] => 90385
[last_post_username] => NY_Sam2
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 524
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1774883337
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 383
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24821] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 93
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24821
[node_id] => 2
[title] => FCC Bans all new routers not made in America
[reply_count] => 9
[view_count] => 975
[user_id] => 35301
[username] => Xebec
[post_date] => 1774376782
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98643
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1,"4":1}
[last_post_date] => 1774762479
[last_post_id] => 98754
[last_post_user_id] => 36448
[last_post_username] => Paul2
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 90
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 35301
[username] => Xebec
[username_date] => 0
[username_date_visible] => 0
[email] => john.heritage@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1647
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1598710106
[last_activity] => 1774867323
[last_summary_email_date] => 1631629203
[trophy_points] => 113
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1760746858
[avatar_width] => 480
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 2021
[warning_points] => 0
[is_staff] => 0
[secret_key] => Y7XyJgQMBi7ZiDtuAyqNGDrBQQsi8JB4
[privacy_policy_accepted] => 1598710106
[terms_accepted] => 1598710106
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24845] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 97
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24845
[node_id] => 2
[title] => Exclusive: Huawei's new AI chip finds favour with ByteDance, Alibaba which plan to place orders, sources say
[reply_count] => 0
[view_count] => 519
[user_id] => 29441
[username] => tonyget
[post_date] => 1774664864
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98747
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774664864
[last_post_id] => 98747
[last_post_user_id] => 29441
[last_post_username] => tonyget
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 94
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 29441
[username] => tonyget
[username_date] => 0
[username_date_visible] => 0
[email] => tonygect@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 524
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1530379703
[last_activity] => 1774863755
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 332
[warning_points] => 0
[is_staff] => 0
[secret_key] => p8Xu8RMcYNG2Mp-_wc8Za9aU-kUYGMwP
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24844] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 101
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24844
[node_id] => 2
[title] => Tesla, ARM Pursue ‘Semiconductor Independence’
[reply_count] => 0
[view_count] => 766
[user_id] => 29441
[username] => tonyget
[post_date] => 1774655371
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98746
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1774655371
[last_post_id] => 98746
[last_post_user_id] => 29441
[last_post_username] => tonyget
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 94
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 29441
[username] => tonyget
[username_date] => 0
[username_date_visible] => 0
[email] => tonygect@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 524
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1530379703
[last_activity] => 1774863755
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 332
[warning_points] => 0
[is_staff] => 0
[secret_key] => p8Xu8RMcYNG2Mp-_wc8Za9aU-kUYGMwP
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24838] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 105
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24838
[node_id] => 2
[title] => AI Boom Accelerates China's Chip Industry Growth as Demand Strains Supply Chain
[reply_count] => 1
[view_count] => 746
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1774539993
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98726
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774650907
[last_post_id] => 98745
[last_post_user_id] => 36640
[last_post_username] => soAsian
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15424
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1774857371
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 92
[alerts_unread] => 92
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9303
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24831] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 109
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24831
[node_id] => 2
[title] => Trendforce: Samsung Reportedly to Build a New Wafer Fab in the U.S.
[reply_count] => 7
[view_count] => 1159
[user_id] => 19450
[username] => user nl
[post_date] => 1774436880
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98671
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774582644
[last_post_id] => 98741
[last_post_user_id] => 16950
[last_post_username] => benb
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 54
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 19450
[username] => user nl
[username_date] => 0
[username_date_visible] => 0
[email] => mauricehmjanssen@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Europe/Amsterdam
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 524
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1424291496
[last_activity] => 1774883337
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 1726169369
[avatar_width] => 384
[avatar_height] => 384
[avatar_highdpi] => 1
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 383
[warning_points] => 0
[is_staff] => 0
[secret_key] => V-1lb5_AW69yhzqA5ok9b64U0fMjJiqf
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24837] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 113
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24837
[node_id] => 2
[title] => Inside the TSMC Patent: How Himax Quietly Became a Key Link in the CPO Supply Chain
[reply_count] => 0
[view_count] => 706
[user_id] => 398583
[username] => karin623
[post_date] => 1774538502
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98722
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774538502
[last_post_id] => 98722
[last_post_user_id] => 398583
[last_post_username] => karin623
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 110
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 398583
[username] => karin623
[username_date] => 0
[username_date_visible] => 0
[email] => karin623@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => Asia/Hong_Kong
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 40
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1748753435
[last_activity] => 1774538502
[last_summary_email_date] => 1771856462
[trophy_points] => 18
[alerts_unviewed] => 5
[alerts_unread] => 5
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 63
[warning_points] => 0
[is_staff] => 0
[secret_key] => PBnrLVmUtkEL7YUKL8Ij_6L3tfKYRzDQ
[privacy_policy_accepted] => 1748753435
[terms_accepted] => 1748753435
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24836] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 117
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24836
[node_id] => 2
[title] => GlobalFoundries Files Patent Infringement Lawsuits Against Tower Semiconductor to Protect High-Performance American Chip Innovation
[reply_count] => 0
[view_count] => 785
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1774537747
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98721
[first_post_reaction_score] => 0
[first_post_reactions] => {"4":1}
[last_post_date] => 1774537747
[last_post_id] => 98721
[last_post_user_id] => 5
[last_post_username] => Daniel Nenni
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15424
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1774857371
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 92
[alerts_unread] => 92
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9303
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24820] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 121
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24820
[node_id] => 2
[title] => Microsoft-backed startup Lace raises $40m series A
[reply_count] => 11
[view_count] => 960
[user_id] => 5
[username] => Daniel Nenni
[post_date] => 1774370847
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98636
[first_post_reaction_score] => 2
[first_post_reactions] => {"1":2}
[last_post_date] => 1774532995
[last_post_id] => 98716
[last_post_user_id] => 15615
[last_post_username] => U235
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 58
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 5
[username] => Daniel Nenni
[username_date] => 0
[username_date_visible] => 0
[email] => dnenni@semiwiki.com
[custom_title] => Founder
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 3
[secondary_group_ids] => 4,5,132
[display_style_group_id] => 3
[permission_combination_id] => 88
[message_count] => 15424
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1280720820
[last_activity] => 1774857371
[last_summary_email_date] => 1605968657
[trophy_points] => 113
[alerts_unviewed] => 92
[alerts_unread] => 92
[avatar_date] => 1663211649
[avatar_width] => 110
[avatar_height] => 107
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 1
[is_admin] => 1
[is_banned] => 0
[reaction_score] => 9303
[warning_points] => 0
[is_staff] => 1
[secret_key] => 0HwyUVVHCwJotUUVEpvqAclfYJdGNPpw
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24834] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 125
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24834
[node_id] => 2
[title] => Cu-Cu hybrid bonding, BESI or a Korean company?
[reply_count] => 2
[view_count] => 709
[user_id] => 90385
[username] => NY_Sam2
[post_date] => 1774469201
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98694
[first_post_reaction_score] => 1
[first_post_reactions] => {"1":1}
[last_post_date] => 1774495469
[last_post_id] => 98707
[last_post_user_id] => 322006
[last_post_username] => freshshine1
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 122
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 90385
[username] => NY_Sam2
[username_date] => 0
[username_date_visible] => 0
[email] => petekennedy1989@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 33
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1642621712
[last_activity] => 1774787550
[last_summary_email_date] => 1767709207
[trophy_points] => 18
[alerts_unviewed] => 12
[alerts_unread] => 12
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 48
[warning_points] => 0
[is_staff] => 0
[secret_key] => egi-LmWHpsbQRZ7Y0Lk56hMyhUsrDhDE
[privacy_policy_accepted] => 1642621712
[terms_accepted] => 1642621712
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24832] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 129
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24832
[node_id] => 2
[title] => OpenAI shutters AI video generator Sora in abrupt announcement
[reply_count] => 6
[view_count] => 1016
[user_id] => 29441
[username] => tonyget
[post_date] => 1774440349
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98675
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774486649
[last_post_id] => 98701
[last_post_user_id] => 138698
[last_post_username] => bilau
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 94
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 29441
[username] => tonyget
[username_date] => 0
[username_date_visible] => 0
[email] => tonygect@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/Los_Angeles
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 524
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1530379703
[last_activity] => 1774863755
[last_summary_email_date] =>
[trophy_points] => 63
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 332
[warning_points] => 0
[is_staff] => 0
[secret_key] => p8Xu8RMcYNG2Mp-_wc8Za9aU-kUYGMwP
[privacy_policy_accepted] => 0
[terms_accepted] => 0
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[24835] => ThemeHouse\XPress\XF\Entity\Thread Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 133
[rootClass:protected] => XF\Entity\Thread
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[thread_id] => 24835
[node_id] => 2
[title] => Antifuse OTP ROM
[reply_count] => 0
[view_count] => 437
[user_id] => 443958
[username] => jonsmirl
[post_date] => 1774471834
[sticky] => 0
[discussion_state] => visible
[discussion_open] => 1
[discussion_type] => discussion
[first_post_id] => 98696
[first_post_reaction_score] => 0
[first_post_reactions] => []
[last_post_date] => 1774471834
[last_post_id] => 98696
[last_post_user_id] => 443958
[last_post_username] => jonsmirl
[prefix_id] => 0
[tags] => []
[custom_fields] => []
[vote_score] => 0
[vote_count] => 0
[featured] => 0
[type_data] => []
[index_state] => default
)
[_relations:protected] => Array
(
[User] => ThemeHouse\XLink\XF\Entity\User Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 130
[rootClass:protected] => XF\Entity\User
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[user_id] => 443958
[username] => jonsmirl
[username_date] => 0
[username_date_visible] => 0
[email] => jonsmirl@gmail.com
[custom_title] =>
[language_id] => 1
[style_id] => 0
[style_variation] =>
[timezone] => America/New_York
[visible] => 1
[activity_visible] => 1
[user_group_id] => 2
[secondary_group_ids] =>
[display_style_group_id] => 2
[permission_combination_id] => 8
[message_count] => 1
[question_solution_count] => 0
[conversations_unread] => 0
[register_date] => 1774469513
[last_activity] => 1774783685
[last_summary_email_date] => 1774469513
[trophy_points] => 1
[alerts_unviewed] => 0
[alerts_unread] => 0
[avatar_date] => 0
[avatar_width] => 0
[avatar_height] => 0
[avatar_highdpi] => 0
[avatar_optimized] => 0
[gravatar] =>
[user_state] => valid
[security_lock] =>
[is_moderator] => 0
[is_admin] => 0
[is_banned] => 0
[reaction_score] => 0
[warning_points] => 0
[is_staff] => 0
[secret_key] => lQp9Y51CVAEcxuztMGtEFiEB6YYCLVqh
[privacy_policy_accepted] => 1774469513
[terms_accepted] => 1774469513
[vote_score] => 0
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
[Forum] => XF\Entity\Forum Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 56
[rootClass:protected] => XF\Entity\Forum
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[discussion_count] => 8474
[message_count] => 62027
[last_post_id] => 98769
[last_post_date] => 1774875154
[last_post_user_id] => 19450
[last_post_username] => user nl
[last_thread_id] => 24852
[last_thread_title] => OFC 2026 Summary: How Silicon Photonics, CPO, OCI, and OCS Are Redefining the Physical Boundaries of Data Centers
[last_thread_prefix_id] => 0
[moderate_threads] => 0
[moderate_replies] => 0
[allow_posting] => 1
[count_messages] => 1
[auto_feature] => 0
[find_new] => 1
[allow_index] => allow
[index_criteria] =>
[field_cache] => []
[prefix_cache] => []
[prompt_cache] => []
[default_prefix_id] => 0
[default_sort_order] => last_post_date
[default_sort_direction] => desc
[list_date_limit_days] => 0
[require_prefix] => 0
[allowed_watch_notifications] => all
[min_tags] => 0
[forum_type_id] => discussion
[type_config] => {"allowed_thread_types":["poll"]}
)
[_relations:protected] => Array
(
[Node] => XF\Entity\Node Object
(
[_uniqueEntityId:XF\Mvc\Entity\Entity:private] => 55
[rootClass:protected] => XF\Entity\Node
[_useReplaceInto:protected] =>
[_newValues:protected] => Array
(
)
[_values:protected] => Array
(
[node_id] => 2
[title] => SemiWiki Main Forum ( Ask the Experts! )
[description] => Post your questions to the experts here!
[node_name] =>
[node_type_id] => Forum
[parent_node_id] => 1
[display_order] => 1
[display_in_list] => 1
[lft] => 2
[rgt] => 3
[depth] => 1
[style_id] => 0
[effective_style_id] => 0
[breadcrumb_data] => {"1":{"node_id":1,"title":"Main Category","depth":0,"lft":1,"node_name":null,"node_type_id":"Category","display_in_list":true}}
[navigation_id] =>
[effective_navigation_id] =>
)
[_relations:protected] => Array
(
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[_previousValues:protected] => Array
(
)
[_options:protected] => Array
(
)
[_deleted:protected] =>
[_readOnly:protected] =>
[_writePending:protected] =>
[_writeRunning:protected] =>
[_errors:protected] => Array
(
)
[_whenSaveable:protected] => Array
(
)
[_cascadeSave:protected] => Array
(
)
[_behaviors:protected] =>
)
)
[populated:protected] => 1
)
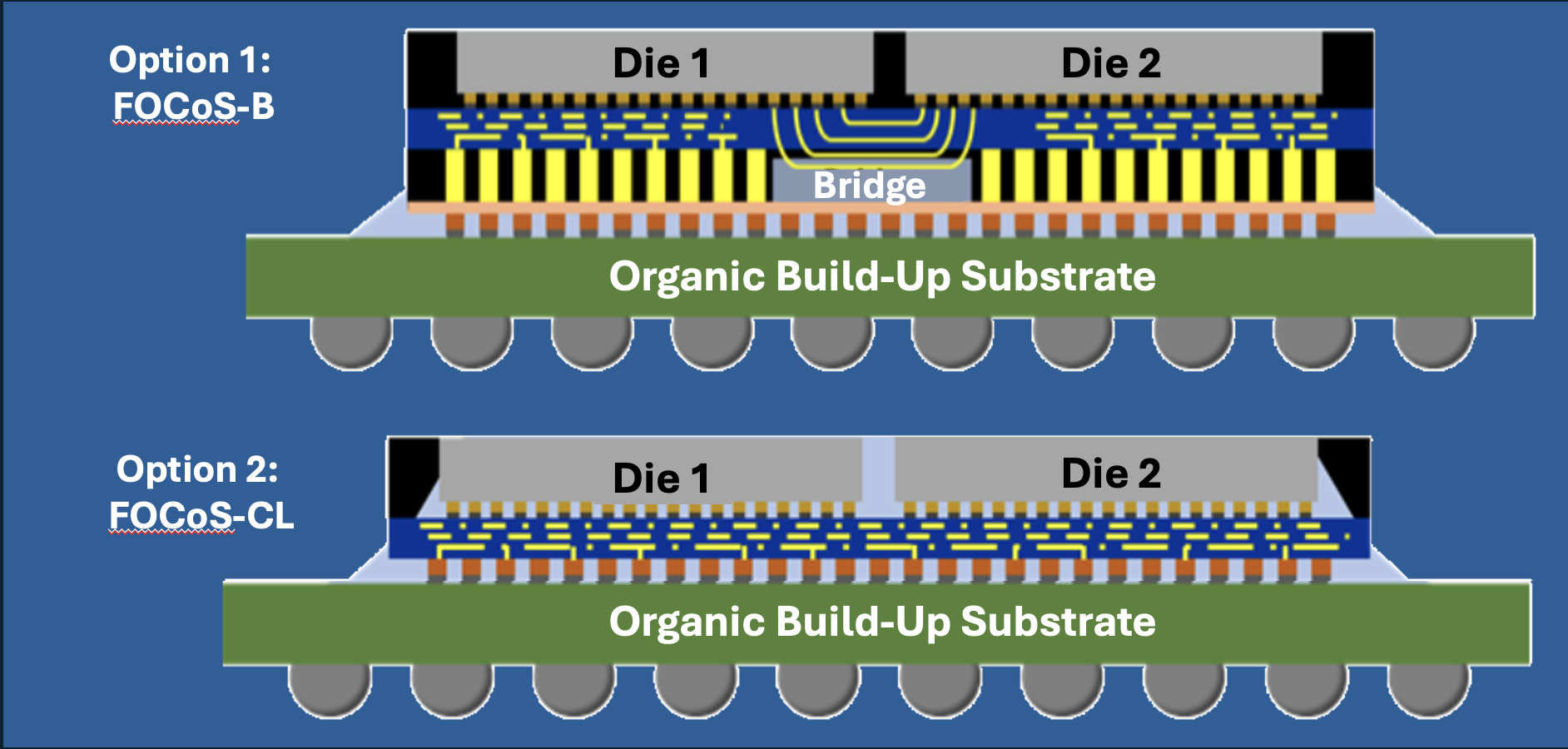
 If you are a sci-fi movie buff, the term “transformer” might bring to mind something interesting, but it’s not relevant to the innovation discussed here for 2.5D package design. What Sarcina is addressing is the cost and complexity of the package for 2.5D designs.
If you are a sci-fi movie buff, the term “transformer” might bring to mind something interesting, but it’s not relevant to the innovation discussed here for 2.5D package design. What Sarcina is addressing is the cost and complexity of the package for 2.5D designs.





Comments
There are no comments yet.
You must register or log in to view/post comments.