There is ample evidence that technologies such as high-performance computing, next-generation servers, and AI accelerators are fueling unprecedented demands in data processing speed with massive data storage, lower latency, and lower power. Heterogeneous system integration, more commonly called 2.5 and 3D IC design, … Read More
A Master Class with Ansys and Synopsys, The Latest Advances in Multi-Die Design
2.5D and 3D multi-die design is rapidly moving into the mainstream for many applications. HPC, GPU, mobile, and AI/ML are application areas that have seen real benefits. The concept of “mix/match” for chips and chiplets to form a complex system sounds deceptively simple. In fact, the implementation and analysis techniques required… Read More
MZ Technologies is Breaking Down 3D-IC Design Barriers with GENIO
3D-IC design can be both exciting and frustrating. It’s exciting because it opens a new world of innovation possibilities – opportunities that aren’t constrained by the rules of monolithic chip scaling. It can be frustrating because of the large array of complex technical challenges that must be overcome to make this new paradigm… Read More
Silicon Creations is Fueling Next Generation Chips
Next generation semiconductor design puts new stress on traditionally low-key parts of the design process. One example is packaging, which used to be the clean-up spot at the end of the design. Thanks to chiplet-based design, package engineers are now rock stars. Analog design is another one of those disciplines.
Not long ago,… Read More
Alchip is Paving the Way to Future 3D Design Innovation
At the recent TSMC OIP Ecosystem Forum in Santa Clara, there was an important presentation that laid the groundwork for a great deal of future innovation. Alchip and its IP and EDA partner Synopsys presented Efficient 3D Chiplet Stacking Using TSMC SoIC. The concept of 3D, chiplet-based design certainly isn’t new. SemiWiki maintains… Read More
The Chips R&D Program Seeks to Accelerate Innovation
The CHIPS and Science Act has allocated $11 billion for semiconductor R&D, including for advanced packaging and AI-driven design. Companies should apply now.
In 2022, the United States signed the $50 billion Chips and Science Act. Under the act, the National Institute of Standards and Technology (NIST), which is part of … Read More
Synopsys-Ansys 2.5D/3D Multi-Die Design Update: Learning from the Early Adopters
The demand for high-performance computing (HPC), data centers, and AI-driven applications has fueled the rise of 2.5D and 3D multi-die designs, offering superior performance, power efficiency, and packaging density. However, these benefits come with myriads of challenges, such as multi-physics, which need to be addressed.… Read More
Sarcina Democratizes 2.5D Package Design with Bump Pitch Transformers
2.5D package design is rapidly finding its stride in a wide variety of applications, including AI. While there are still many challenges to its widespread adoption, the chiplet approach is becoming more popular compared to monolithic design. However, the required market to create a chiplet ecosystem is still under development.… Read More
Analog Bits Builds a Road to the Future at TSMC OIP
The TSMC Open Innovation Platform (OIP) Ecosystem Forum has become the industry benchmark when it comes to showcasing industry-wide collaboration. The extreme design, integration and packaging demands presented by multi-die, chiplet-based design have raised the bar in terms of required collaboration across the entire … Read More
Navigating Resistance Extraction for the Unconventional Shapes of Modern IC Designs
The semiconductor industry is experiencing rapid evolution, driven by the proliferation of IoT applications, image sensors, photonics, MEMS applications, 3DIC and other emerging technologies. This growth has dramatically increased the complexity of integrated circuit (IC) design. One aspect of this complexity is the … Read More





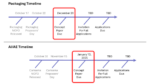

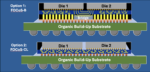
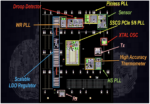

Chemical Origins of Environmental Modifications to MOR Lithographic Chemistry